高温处理对Si图形衬底上SiO2掩膜层的影响
侯凯文 朱永琴
黄河交通学院,河南 焦作 454950
SiC具有禁带宽度大、热导率高、电子迁移率大、临界击穿电场高等特点,在高温、高压、大功率器件领域有广泛的应用。但Si衬底上异质外延3C-SiC薄膜的质量较低,阻碍了其在各应用领域的发展。在SiC和Si衬底界面处或外延薄膜内会产生大量的由应力释放引起的缺陷,如位错、层错、孪晶等[1-2]。图形化衬底上侧向外延生长技术可以有效地解决这一问题,这一技术在选择性生长的基础上发展而来。图形化衬底可以采用干法刻蚀或湿法刻蚀工艺获得,有微米级波浪形、“V”形,纳米柱状等[3-7]。图形化衬底分为有掩膜图形和无掩膜图形两类,掩膜材料有SiO2、Si3N4或金属等[8-11]。目前在图形化蓝宝石衬底上侧向生长的GaN材料的位错密度由108/cm2以上降低至107/cm2[12]。Oshita等人在Si(100)衬底上用SiO2作掩膜图形,在1000 ℃得到了质量良好的3C-SiC薄膜。通过侧向外延技术的选择性生长可以最大程度地减少3C-SiC薄膜中的缺陷[13-14]。然而掩膜材料和最优选择性生长工艺之间的矛盾关系是侧向外延生长中必须要考虑的因素,较高的生长温度可以获得质量更好的3C-SiC薄膜,但是低的生长温度可以减少对SiO2掩膜材料的伤害,SiO2掩膜图形层的完整性决定着外延薄膜的生长质量[3]。在本论文工作中,通过3组实验来对比研究高温以及高温下通入H2和C2H2气体对Si(100)衬底上SiO2掩膜图形的影响。
1 实验过程
本论文使用P型Si(100)衬底,电阻率2~10 Ω · cm,干氧氧化在Si衬底生长SiO2层,厚度分别是300 nm和500 nm。所有的衬底都经RCA标准清洗,后进行光刻,形成图形,再利用HF和NH4F组成的缓冲液对SiO2层进行湿法刻蚀,得到有SiO2掩膜层的图形化衬底。刻蚀的图形为条形,其尺寸为15 μm或20 μm。衬底图形制作过程如图1所示,图形窗口边沿(110)方向。
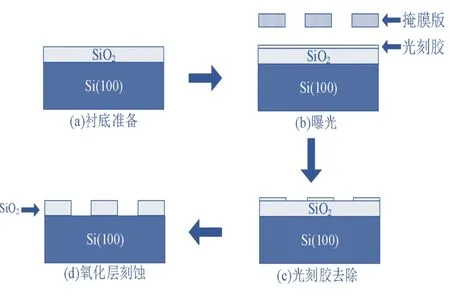
图1 硅基图形化衬底制备流程
将衬底放入低压化学气相淀积(LPCVD)设备的腔体中,分别在1200 ℃下的真空气氛、 H2气氛和H2与C2H2的 混合气氛中进行处理。H2和C2H2是LPCVD法外延生长3C-SiC薄膜使用的气体。具体参数如表1所示,其中第Ⅲ组实验参数中通入H2保持10 min后,再通C2H2并保持6 min。

表1 衬底处理的具体参数
通过光学显微镜和扫描电子显微镜(JEOL,JSM-6700 F)观察图形衬底上SiO2的表面形貌变化。
2 实验结果与分析
2.1 真空气氛下高温处理对SiO2掩膜层的影响
外延薄膜在图形衬底上选择性生长的过程中,最重要的步骤是要保持SiO2掩膜层的完整度。实验前将衬底清洗干净并干燥,通过光学显微镜检查衬底表面有无污染物颗粒,且SiO2掩膜图形层是否完整。将氧化层300 nm厚度的样品命名为样品A,氧化层500 nm厚度的衬底命名为样品B。图2是真空气氛下高温处理前后各样品的光学显微镜图片。
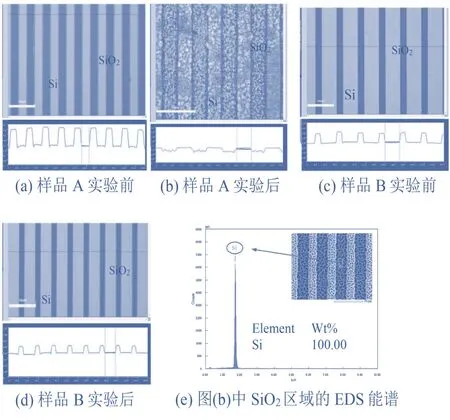
图2 第Ⅰ组实验处理前后两种衬底的光学显微镜图
图2a和图2c分别是样品A和样品B真空气氛条件下高温处理前衬底的共聚焦显微镜俯视图,图2b和图2d分别是处理后的图片。图2a至图2d的上半部分为俯视图,下半部分为横截面图。图2e是图2b SiO2区域的EDS能谱。
对比图2a和图2c,可以发现在实验处理前样品A的表面掩膜层图形完整,表面平整,没有污染物颗粒,厚度均匀。而在第Ⅰ组实验处理后(实验参数如表1 中Ⅰ组所示),样品A表面掩膜层所在的区域由实验前高出Si衬底表面变成低于Si衬底表面,发生“凹陷”现象,且衬底表面粗糙度增加。出现此现象的原因是:SiO2氧化层与Si衬底界面处或氧化层内部的缺陷(缺陷可能在氧化层生长过程中产生)经过高温真空处理后形成孔洞,衬底表层的Si原子在高温促使下扩散至氧化层孔洞处,并在孔洞处发生化学反应,如式(1)所示,生成挥发性气体SiO,生成的气体不断积累,并随缺陷逐渐穿透整个氧化层,Si衬底表面和氧化层表面的连通加快了反应生成物SiO气体的扩散,整个过程所需时间与氧化层的厚度相关。衬底表面的氧化层厚度越薄(<300 nm),氧化层退化所需的时间就越短。

此外,有研究发现,当环境温度高于800℃时,SiO气体有较大的平衡压力(1200℃时其值为10-4pa),对SiO2层产生热应力,加剧氧化层的分解[14],所以出现图2b所示的衬底氧化层图形区域“凹陷”的现象。另外,在反应停止后的冷却过程中,实验设备腔体中 Si原子逐渐形成硅晶核吸附在整个衬底表面,增加了样品表面的粗糙度。对比图2c和图2d可以看出,样品B的表面形貌在实验处理前后变化较小,仅部分SiO2掩膜图形退化,未发生氧化层图形区域 “凹陷”的现象。因此,在选择SiO2做掩膜材料的Si图形化衬底上选择性生长3C-SiC薄膜时,若环境温度超过1200 ℃,需使用厚度在500 nm以上的氧化层做掩膜,才可减弱掩膜层的退化。
2.2 高温环境下H2和C2H2对图形化衬底上SiO2氧化层的影响
通过第Ⅱ组实验,观察高温下通入H2对Si衬底上图形氧化层的影响(实验参数如表1 中Ⅱ组所示)。3组实验所用衬底和实验设备均相同。从图2b和图3a可以看出,在通入H2的高温环境下,仅部分氧化层退化,氧化层退化现象减弱,未出现第Ⅰ组实验后样品A表面发生化学反应氧化层图形“凹陷”的情况。产生上述现象的原因是:1200 ℃下,在实验设备腔体内通入H2,H2与SiO2发生如式(2)所示的化学反应,生成气态SiO和H2O,图形氧化层损耗,膜厚降低。另外,由于式(2)与式(1)所示的化学反应同时发生,加快了SiO2掩膜图形层的退化,使Si衬底与SiO2氧化层的界面处未出现过度反应现象。由于此反应不均匀性较明显,所以氧化层出现部分退化情况。H2是活性气体,会在高温环境下同时与衬底窗口区域的Si原子和衬底表面自然氧化层发生反应,两者反应速率不同,在Si衬底表面形成了复杂的反应,导致样品窗口区域的粗糙度增加,最终出现样品表面高低不明显的现象[15]。从图3b中可以看出氧化层厚度达500 nm时,在高温环境下通入H2对样品表面的影响较小,样品表面的部分氧化层依然平整,仅氧化层图形边缘部分被退化,衬底图形保存较完整。图中氧化层颜色差异由光学显微镜的图像色差引起,不是实验造成的。


图3 第Ⅱ、Ⅲ组实验处理后样品A和样品B表面形貌的光学显微镜图
对比图3c和图3d发现,样品A和样品B表面的氧化层变化不大,说明在1200 ℃下的H2气氛中通入C2H2,不会影响掩膜层为SiO2的图形化Si衬底的质量。
3 总 结
图形化衬底上SiO2掩膜层厚度为300 nm时,在1200 ℃真空气氛下,由于Si和SiO2的化学反应,使图形化衬底上的氧化层出现较严重的退化现象,并且造成氧化层处Si衬底形成“凹陷”;在通入H2后,由于H2同时对Si和SiO2的刻蚀,缩短了衬底与氧化层之间的反应时间,使图形化衬底未出现SiO2与Si衬底过度反应导致的衬底“凹陷”现象;在通入C2H2后,图形化衬底上未出现氧化层继续退化的现象。当SiO2掩膜层厚度为500 nm时,图形化衬底上只有部分氧化层发生退化,基本保持了图形化衬底上掩膜图形的完整性。

