浅谈对集成电路加速寿命试验的认识
颜 燕,帅
(中国电子科技集团公司第58研究所,江苏 无锡 214035)
1 前言
从集成电路(IC)的诞生开始,不断提升产品使用寿命一直是IC设计、制程研究开发和产品生产中的一个重要部分。在系统集成的电子信息时代,几乎所有电子产品都由众多不同种类的IC整合而成,任何一块IC的质量和可使用时间都影响到整个系统的稳定性,甚至对系统造成毁灭性的后果,而使其他原本完好的电路也变成废品。因此,集成电路的使用寿命是产品可靠性最重要的量化特征,体现了IC生产商的核心竞争力。
2 集成电路的可靠性指标
通常用于评价集成电路长期使用寿命的指标为MTTF(Mean Time To Failure,平均无故障时间),另一个常见的单位为FIT(Failure in Time),用于表征集成电路长期失效率,定义为每109元器件-小时(device-hour)所发生的失效数。二者互为反比关系,公式为MTTF=109/FIT。
自20世纪90年代初期亚微米的工艺制程,乃至2000年0.18μm的深亚微米工艺,集成电路不仅在面积上缩小了50倍以上,性能和应用范围也得到大幅提升,尤其是可靠性寿命也提升了一个量级,由数十个FIT达到了数个FIT。

图1 集成电路预计寿命发展图
3 集成电路的失效特征
集成电路的失效率与时间的关系可以用一条浴盆曲线(Bathtub Curve)来表示,见图2。
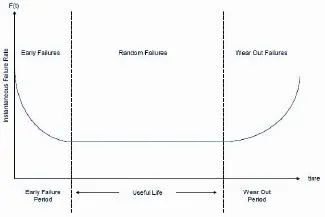
图2 集成电路失效“浴盆曲线”
大体上,集成电路的失效率分三个阶段呈现不同特征。
3.1 早期失效期
这个阶段产品的总体失效率相对偏高并快速下降,造成失效的原因在于IC设计和生产过程中的缺陷,比如离子沾污等,一般用PPM(Parts Per Million,百万分之一)表示,该阶段器件的失效率与时间的关系符合韦伯分布(Weibull Distribution)。
3.2 使用期
这个阶段产品的失效率保持稳定,失效的原因往往是随机的,比如静电放电(ESD)、电过载(EOS)或氧化层缺陷等,一般用FIT表示。该阶段器件的失效率与时间的关系符合指数分布(Exponential Distribution)。
3.3 损耗期
在这个阶段失效率会快速升高,失效的原因是产品的长期使用所造成的老化等,失效机理包括电迁移(EM)、热载流子注入(HCI)等。一般以年为单位,并要求十年以上的损耗期。该阶段器件的失效率与时间的关系符合对数正态分布(Lognormal Distribution)。
4 加速寿命试验的意义
结合以上典型集成电路产品的生命周期,可见加速寿命试验重点要解决的问题是:
(1)将处于早期失效期的产品去除,并估算产品良率;
(2)预计产品的使用寿命期限,查找失效原因,尤其是工艺、封装、存储等方面的失效原因。
针对上述两点,主要进行两项加速寿命试验,包括老炼(Burn in)试验、稳态寿命(High Temperature Operating,简称HTOL)试验,见图2。
4.1 老炼试验
老炼试验有时也被称为早期失效试验(Early Fail Test,简称EFT),在国军标GJB548B-2005《微电子器件试验方法和程序》方法1015中对专用产品的试验要求做了详细规定。
老炼试验的目的是评估工艺的稳定性,加速缺陷失效速率。老炼试验要求至少125℃、160h,并加偏压的条件下对产品进行测试。测试结束后剔除由于先天原因引起的早期失效产品,并可供计算PPM。
4.2 稳态寿命试验
稳态寿命试验是评估器件长期使用失效率的方法,在国军标GJB548B-2005方法1005中对专用产品的试验要求做了详细规定。另外MIL-PRF-38535规定,对每种晶圆工艺,从每季度生产的产品中抽取样品进行至少125℃下进行1 000h或等效条件的测试,失效判据为45(0),见表1。
一般而言,通过125℃、1 000h试验的产品可以保证持续使用4年,通过2 000h试验的可保证持续使用8年;通过150℃、1 000h试验的产品可以保证持续使用8年,通过2 000h试验的可保证持续使用28年。当然,这仅仅是对电性能而言,在储存期较长且非真空包装的情况下,更多需要考虑的还包括如何防止电路吸潮、引脚锈蚀等。

表1 稳态寿命试验等效试验条件表
[1]谢国华. IC产品可靠度简介[J].电子与材料,2002, 8.
[2]微电子器件试验方法和程序[R]. GJB548B-2005.
[3]MIL-PRF-38535H. PERFORMANCE SPECIFICATION:INTEGRATED CIRCUITS(MICROCIRCUITS)MANUFACTURING[A]. United States Department of Defense. 2007.

