MBE生长GaAsBi过程中Bi组分对背景杂质含量的影响
张 凡, 潘文武, 王利娟, 张焱超, 宋禹忻, 张立瑶, 吴晓燕, 王庶民,4*
(1. 中国科学院 上海微系统与信息技术研究所, 上海 200050; 2. 上海科技大学 物质科学与技术学院, 上海 201210;3. 中国科学院大学, 北京 100190; 4. 查尔姆斯理工大学 微技术和纳米科学系, 瑞典 哥德堡 41296)
众所周知,半导体晶体一般都含有各种各样的杂质,如:C、H、O、N等.这些杂质的存在将会影响原子的周期性势场,从而在半导体禁带中引入杂质能级,影响材料的电学和光学性质.从已有的研究结果发现,在AlGaAs材料中,O作为一种深能级非辐射受主陷阱,会减小辐射效率[1-2].在GaAs中,如果有C的存在,晶格会发生收缩[3].在InGaNAs量子阱中,N的引入会使发光效率减小[4].而在P型GaAs中,H可以充当浅受主杂质的钝化层[5].
分子束外延(MBE)作为一种高端的外延技术,被广泛地应用在高质量半导体异质结构和纳米结构材料的生长中.虽然MBE工作在超高真空的环境下,但是通过MBE腔体中的残余气体分析仪(RGA)发现,在MBE背景真空中仍然有许多残留气体和其他的元素.图1是在用DCA P600 MBE系统生长砷化物时,观测到的一幅比较典型的RGA图谱.在图中可以看到,有氢气(相对分子质量2)、氮气(相对分子质量28)、砷(相对分子质量75)和As2(相对分子质量150)等的峰.在一个密闭且不漏气的MBE腔室中,通常情况下不存在氧气(相对分子质量32),但是如果铝源和砷源等源材料不纯净,那么腔室中就可能会引入氧气.此外,MBE设备中的金属构件,在加热条件下会释放出碳.

图 1 生长砷化物时,MBE中典型的RGA图谱
低温生长时,这些杂质粒子的碰撞黏附效率会增加,从而影响半导体材料的质量.比如,在用MBE设备生长GaAs/AlGaAs量子阱材料时,高的背景杂质含量就会导致二维电子气迁移率的下降,并且出现显著的各向异性传输[6].
含铋半导体有许多特殊的性质,比如:较大的带隙收缩、带隙对温度不敏感、非常大的自旋分裂能以及表面活性剂效应等[7-12].因此,含铋化合物半导体在近些年受到了越来越多的关注和研究.然而,铋原子相对其它V族元素而言,原子半径大而且键能弱,所以要想在半导体中掺入适当组分的铋,就需要采用相对较低的生长温度,通常在350 ℃以下[13].在这么低的生长温度下,杂质的含量也会增加.研究发现,当掺入的铋组分不高时,材料中电子和空穴的迁移率几乎不受影响[14-16].但是,在相同的生长温度下,GaAsBi、InPBi和GaSbBi体材料的光致发光强度(PL)相对于没有铋的情况,会有显著的增强[17-19].掺入铋可以提高材料光学质量的原因目前尚不清楚.有很多可能的原因,Segercrantz等[20]用正电子湮没的方法证实了引入铋可以减小三族的空位,从而减小材料的本征缺陷,提高材料质量.也有研究人员提出,局域态的存在是使GaAsBi获得强PL的可能原因之一[21],但是对于高质量的稀铋材料,没有观察到S型温度依赖性的PL,表明局域态是可以忽略不计的[22].此外,已有的研究表明,背景杂质碳和氧可以影响半导体材料(AlGaAs)的PL强度[1,23].那么铋的引入是否会减小背景杂质的含量,从而改进材料的质量呢?本文详细研究了MBE外延生长GaAsBi过程中,铋的掺入对外延材料中背景杂质含量分布的影响.
1 样品生长与测试
实验所用样品是在半绝缘GaAs(001)衬底上使用P600固态源MBE系统外延生长所得.GaAs(Bi)的生长速率为0.4 mL/s,生长温度通过热电偶来进行监控.Ga、As2和Bi的等效束流压力(BEP)通过一个可伸缩的离子规来测量.在样品结构中设计了两个区域,用来研究铋对界面处和体内杂质含量的影响.图2展示了样品结构和生长细节的信息.首先,在720 ℃条件下,生长了100 nm厚的GaAs缓冲层,接着在500 ℃条件下,生长了500 nm厚的GaAs,每层厚度100 nm,在每层之间,生长停顿30 min.在层和层的界面处,As2源和Bi源闸板的开关具有不同的状态,用以研究背景杂质(C、H、O、N)在界面处的吸附作用.在生长中断期间,通过控制As源和Bi源的开关来研究铋和砷对于界面处背景杂质含量的影响.之后,进行GaAs1-xBix的外延生长,各层铋的含量分别为x=0.05,0.03,0.00,0.01.另外,为了校准铋源的温度,保证生长温度稳定在一个相对较低的温度条件下(410 ℃),在各层之间有5 min的生长停顿.最后,外延150 nm厚的GaAs覆盖层,用以防止氧化.GaAs1-xBix样品的结构特性,通过配备了四晶Ge(220)单色仪的高分辨率X射线衍射仪(HRXRD)测量分析.背景杂质含量的分布则通过EAG公司的Adapt 1010 SIMS设备测试获得.侦测极限大于1010at/cm3.
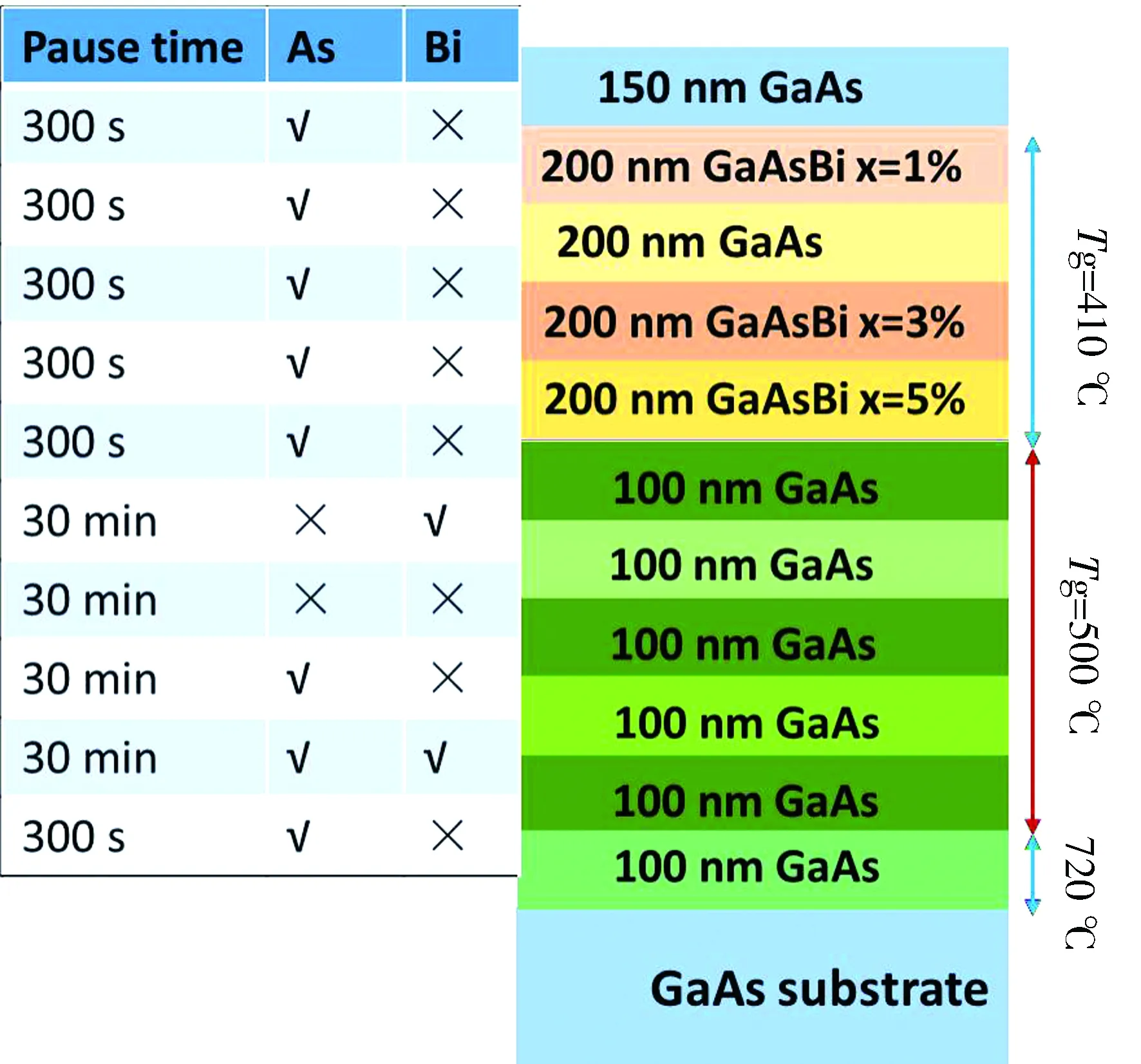
图 2 GaAs1-xBix的样品结构

图 3 GaAs1-xBix样品(004)和(115)晶面的高分辨率X射线衍射摇摆曲线测试谱
图3是GaAs1-xBix样品的HRXRD(004)和(115)晶面的ω-2θ摇摆曲线测试图.图中最右边的峰为衬底峰,半峰宽约为20″.左边的几个峰为外延层的峰.x=0.01的峰和右侧GaAs衬底的峰有部分交叠.通过对摇摆曲线的模拟分析可得到掺入铋的组分,模拟分析时,GaBi的晶格常数采用0.632 nm[7].根据对称的(004)晶面和非对称的(115)晶面扫描结果分析,GaAs1-xBix样品x=1%,3%,5%各外延层相对于衬底完全应变.
2 实验结果与讨论
使用二次离子质谱来分析背景杂质的含量分布.图4为GaAsBi样品中碳和铋含量随深度的分布图.深度分辨率小于5 nm.红色实线代表铋含量的分布随深度的变化.黑色实线表示碳的含量随深度的变化.蓝色和紫色虚线表示界面.在深度1 500 nm即衬底的位置处,可以看到有一个比较高的C的峰位.如图4中蓝色实线所示,当生长温度从720 ℃降低到500 ℃再到410 ℃时,相应的背景杂质碳含量的平均值也依次从(2.4±0.8)×1015cm-3变化到(4.6±0.4)×1015cm-3和(4.1±0.5)×1015cm-3.表1为在不同停顿界面处As源和Bi源闸板开关状态.在生长中断了30 min的0~4共5个界面处,没有发现明显的碳含量的变化.GaAs1-xBix中x在0.01和0.03时,铋的含量分布比较均匀,但是当x为0.05时,靠近GaAs1-xBix表面处铋的组分下降比较明显.这一现象很有可能是因为由于存在铋的液滴而产生的铋的表面偏析作用所致.和碳的分布曲线对比,可以发现,在铋和碳之间存在比较明显的关联性.如图5所示,黑色实线表示不掺铋时背景杂质碳随生长温度的变化.红色实线表示生长温度为410 ℃时,不同掺铋浓度对背景杂质碳的影响.碳杂质浓度随生长温度降低而升高,在500 ℃以下趋于饱和.掺入铋可以减小背景杂质碳的含量,而且,碳含量的下降与铋含量的增加呈现一定的正比例关系.当掺入铋的组分为0%、1%、3%、5%时,背景杂质碳的平均含量依次为(4.1±0.5)×1015、(3.1±0.7)×1015、(2.8±0.8)×1015和(2.5±0.8)×1015cm-3.在410 ℃条件下生长的GaAs0.95Bi0.05中背景杂质碳的含量几乎和生长温度为720 ℃的GaAs中碳的含量一样,说明,掺铋可以显著降低背景碳掺杂.
如图6和7所示,可以发现铋含量的分布和氧含量的分布曲线也呈现类似的现象.同样的,在GaAs衬底的位置,可以发现氧的峰值已经达到饱和.随着生长温度的下降,杂质氧的含量明显增加.实验发现,氧的峰值大小和生长中断的时间长短相一致,在有30 min生长中断的4个界面(1~4)处,氧的峰强度很接近,没有太大变化,而在生长停顿时间只有6 min的界面0处,氧的峰值比界面1~4要小.在衬底以上的600 nm GaAs外延层中,上面的300 nm厚的GaAs层可以观察到氧峰位的凹陷,在中间的200 nm厚的外延层中,可以观察到氧峰位的凸起.对比图2所示的样品结构,可以发现,由于中间的200 nm厚的GaAs在生长时As源打开,且在界面处有30 min的生长中断,从As源释放出了氧,所以可以观察到比较高的氧的峰位.图7为氧含量的分布与铋组分以及温度的关系图,可以发现,当生长温度从720 ℃下降到500 ℃和410 ℃时,氧含量的平均值从(3.1±0.9)×1015cm-3增加到(6.4±0.4)×1015cm-3和(1.9±0.3)×1016cm-3.当掺入铋的组分到3%时,背景杂质氧的含量基本没太大变化,然而当铋的组分增加到5%时,氧的含量下降到1×1016cm-3以下.

图 4 在GaAs衬底上外延生长的GaAs1-xBix中碳含量和铋含量的SIMS测试分布曲线图

表 1 在不同停顿界面处As源和Bi源闸板开关状态
背景杂质氢的分布和铋的含量之间没有像氧、碳和铋那样具有明显的相关性,如图8所示,当掺铋组分0%~1%时,氢的含量比较高,而当生长温度为500 ℃或者掺铋组分超过3%时,氢的含量都在比较低的层级.在x=5%的外延层中出现的氢峰和铋的液滴相关,表明铋原子的累积可能会俘获氢原子.

图 5 碳含量分布与铋含量以及温度变化的关系图

图 6 在GaAs衬底上外延生长的GaAs1-xBix中氧含量和铋含量的SIMS测试分布曲线图

图 7 氧含量的分布与铋组分以及温度的关系图
通过SIMS测试获得的铋含量和氮含量分布的关系图如图9所示.从图示中可以观察到一个非常有意思的现象:氮含量的分布与铋的分布高度相关.不管生长温度和铋的组分如何变化,铋含量的变化和氮含量的变化始终保持步调一致.铋的组分增加,氮的含量也增加,铋的组分减小,氮的含量也减小.但是在生长停顿的几个界面处,打开铋源,对于界面处氮含量没有明显的影响.

图 8 在GaAs衬底上外延生长的GaAs1-xBix中氢含量和铋含量的SIMS测试分布曲线图

图9 在GaAs衬底上外延生长的GaAs1-xBix中氮含量和铋含量的SIMS测试分布曲线图
上述现象表明,由于应变补偿效应的影响,铋的引入可以促进氮的凝入.铋原子半径比较大,当在GaAs中掺入铋时,会产生一定的压应变.氮原子半径比较小,如果在GaAsBi中引入氮,可以补偿铋产生的压应变.
图10展示了一个可解释氮和铋之间应变补偿的替换模型示意图.在用MBE外延材料时,生长温度往往都在几百摄氏度,甚至更高,氮气很容易从腔体和源炉当中释放出来,因此腔体中存在有图1所示的氮气分子,而且N—N键的键能比较大.很难将氮气分子中的N—N键断裂为氮原子,因此几乎不存在N原子替换Ga或者As的位置.实际上,在相对较低温条件下,以比较低的As/Ga束流比生长GaAsBi时,会产生大量的Ga空位[24-25],氮气分子就比较容易填满这些位置,补偿由铋的引入产生的大应变.
3 结束语
在用MBE生长GaAs样品时,铋的引入可以在一定程度上影响背景杂质的含量.降低生长温度会增强背景杂质碳和氧的引入量级.当掺入的铋组分超过3%时,可以明显减小C和O的含量,但是对于氢的分布却没有影响.实验发现了铋和氮的分布呈现很强的相关性,并确认是由于应变补偿造成的.在同样的MBE生长条件下,和GaAs相比,GaAsBi具有更强的光学和输运特性,一个很可能的原因就是铋的引入使GaAs材料中碳和氧含量下降.

图 10 可能的氮的替位模型

