氧化锌单晶生长、载流子调控与应用研究进展
黄 丰,郑 伟,王梦晔,何佳庆,程 璐,李悌涛,徐存华,戴叶婧,李宇强
(中山大学材料学院,国家光电材料与技术国家重点实验室,广州 510000)
0 引 言
氧化锌(ZnO)在自然界中以红锌矿的形式存在,并未发现肉眼可见的单晶晶粒。研究表明,ZnO具有三种结构类型:立方岩盐型、立方闪锌矿型和六方纤锌矿型[1],其中,纤锌矿结构ZnO是天然存在且热力学最稳定的,而其他两种结构的ZnO均需在特殊条件下才可制备或稳定存在。本文仅针对具有应用前景的纤锌矿结构ZnO进行讨论,其空间群属P63mc,晶格常数:a=0.325 0 nm,c=0.520 7 nm[2]。该结构的特征是每一个“Zn2+-O2-偶极子对”方向不变地沿c轴以ABABABAB……密堆积的形式交替累积,形成的微观结构具有非中心对称性,宏观晶体具有+c(Zn面)和-c(O面)两个极性面。
作为一种自然界中存在且很容易通过焙烧铅锌矿制得的“传统”材料,ZnO很早就得到了人们的利用。早期主要利用低纯ZnO(含Pb)的洁白度在涂料和颜料领域使用。之后,随着化学工业的发展,ZnO在橡胶、玻璃、水泥和陶瓷等领域作为化学添加剂来使用。随着提炼技术的提高,人们进一步找到了高纯ZnO在医药方面的一些用途:利用其收敛性、杀菌能力和生物相容性应用于皮肤外用药物、胃酸中和药剂等。可以看到,ZnO在早期只是被当作一种简单的绝缘体化合物来看待,鲜有对其物理特性的细致研究。
在1950年人类进入信息时代后,以下两个重要因素驱动了人们对如ZnO这类“传统”材料的认识发生了革命性变化:(1)信息产业对新光电材料的大量需求;(2)量子力学为根基的固体能带理论的发展。在实验上,人们也开始探究其力、热、声、光和电磁等基本物理参数及其与内部晶体和电子结构之间的关联。ZnO的莫氏硬度较低(4.5),是相对较软的材料,其弹性系数比具有相同晶体结构的GaN等Ⅲ-Ⅴ族半导体材料小得多,容易发生形变。由于晶体内部的极性,ZnO的Zn面与O面热导率不同,分别约为1.16 W/(cm·K)和1.10 W/(cm·K),高于大部分的氧化物材料,与GaN(1.3 W/(cm·K))接近,低于α-SiC(4.90 W/(cm·K)),远低于金刚石(20 W/(cm·K));ZnO还具有相对较低的热膨胀系数(沿a轴为4.75 K-1,沿c轴为2.92 K-1),使它可能在大功率器件应用上具有一定的优势。如前所述,由于其偶极方向不变的交替堆积结构,ZnO的正负离子电荷中心显然不重合,因此在人们通过量子力学和能带论认识到ZnO是半导体之前,它最初主要在介电物理领域被当作压电材料来研究。根据其晶体结构很容易预测出ZnO具有很大的压电系数(实测e33=1.14 C/m2),人们期望在新型机电耦合器件上找到它的应用空间。然而,在实践过程中,为了实现器件应用所制得的ZnO单晶却出现了意外的导电性,这直接限制了它在低频机电耦合领域的应用。在高频机电耦合领域,其应用(如声表面波等)仍在探索中。在非线性光学应用领域,作为一种无对称中心的强极性材料,人们也预测它将具有较大的非线性光学系数(实测二阶有效非线性张量为18 pm/V,与倍频材料KTP相近)[3]。然而,ZnO的a轴与c轴方向折射率差过小,仅为0.021,难以获得非线性倍频器件所需的相位匹配条件(折射率差需达到0.07),因此它在非线性光学领域的应用也未有大的实质性拓展。
ZnO在压电与非线性光学领域的应用期望促进了优质单晶生长技术的发展。作为一种非水溶性晶体,ZnO熔点高达1 975 ℃,大于1 300 ℃易升华,单晶生长困难[4]。迄今人们对以下晶体生长方法均已进行了尝试:助熔剂法[5-9]、化学气相传输法[10-14]、加压熔体法[15-17]和水热法[18-20]。对助熔剂法来说,由于难以找到能将液相线压低至1 200 ℃以下的助熔剂,在接近1 300 ℃ 下生长的晶体本征缺陷过多,几乎无法使用;化学气相传输法有着晶体生长速度较快、容易得到较大尺寸单晶的优点,然而,由于其结晶需在1 100~1 300 ℃之间,已逼近ZnO开始升华的温度,因而难以获得高结晶度的晶体,晶体中高浓度阴、阳离子空位缺陷难以避免,最终将导致许多与光电特性相关的物理参数不稳定,实际应用困难;加压熔体法是美国学者提出的一种特有的晶体生长方法,其原理是使晶体在惰性气体中,高温(1 100 ℃)高压条件下进行生长,从物理上看该法有希望避免上述ZnO升华所造成的空位缺陷,然而,其生长设备条件苛刻,生长成本也十分高昂;水热法是当前公认的ZnO单晶生长最优方法,其原理是利用高压使水的沸点升高,从而将原来100 ℃下难溶于水的氧化物溶解、析出,进行晶体生长,该法的特征是能在相较于熔体法和化学气相传输法低得多的温度下进行生长,这使物质从无序态(生长溶液)到有序态(晶体)转变时的温差极小,通过微调控制温度就能实现溶解和析出之间的可逆变换。因此,从热力学上来说,水热法是一种近热力学平衡的生长,利用该法生长的单晶内部点缺陷密度大幅下降,表面位错密度理论上可控制为零,而其生长速度较慢的缺点可通过生长釜体的放大、生长周期的延长得到解决。因而,在当前技术条件下,水热法逐渐成为ZnO单晶生长的主流。
ZnO被作为半导体材料进行研究与应用是在半导体照明领域的需求牵引下展开的。在20世纪70年代,人们对第二代半导体(GaAs/InP)材料与器件的研究中发现:只要在InP基器件的激发区中掺入适当浓度的“Zn2+-O2-对”后,就可以通过直接电激励高效发射红黄光。这促使人们去寻找更宽禁带的半导体材料,希望通过制备与InP基器件相同的p-i-n结构直接电激励发射蓝光,进而将红黄光和蓝光混合发出照明用白光。因此,诸如SiC、GaN、ZnO这类原本被认为是“绝缘体”的材料逐渐走入半导体学家的研究视野,并被命名为“宽禁带半导体(WBGSs)”材料。其中,SiC是非直接带隙能带结构,无法实现高效率发光,因而发光方向的研究重心就主要放在GaN和ZnO之上,两者所碰到的共同问题是:n型掺杂容易实现,而p型掺杂却难以实现。在材料制备方面,由于高质量的GaN和ZnO单晶一时都难以获得,自20世纪70年代初,这两类材料更多的基础研究都转为在材料制造上更为容易的薄膜领域,使薄膜生长技术的发展有了长足的进步。在薄膜技术的支撑下,人们同时展开了对GaN和ZnO的载流子调控[21]、能带结构[22]、激子束缚[23-24]等方面的研究,这一对“孪生兄弟”平行发展的状况持续了约20年。对于ZnO来说,由于当时材料制备技术的限制,高缺陷密度的ZnO导致紫外受激发射快速猝灭,再加上难以实现p型ZnO掺杂,使得ZnO的研究沉寂了很长一段时间。直到1997年,Bagnall等[25]在室温下得到了ZnO薄膜的光泵浦受激发射,证实了ZnO在低阈值激光方面有着独特的优势,再次激起人们对ZnO在光电子领域应用的研究兴趣。与此同时,在GaN研究领域,经过中村修二等人的不懈坚持,在1995年,人们发现了GaN能够仅通过简单退火而不是电子束辐照就可实现p型导电,而且有着高缺陷密度的GaN发射源仍具有高激励发射。以上发现促进了蓝光LED的出现,是现代半导体照明领域产业的根基。受到GaN材料发展的鼓舞,人们加快了对ZnO p型掺杂的研究投入,2000年,Ohta等[26]制备出最早的ZnO电致发光异质结,并能产生382 nm的紫外光发射;2004年,Tskuazkai等[27]制得ZnO同质p-i-n结并观察到紫色电致发光,同年他们又利用脉冲激光辅助MBE设备获得了稳定可重复的p型ZnO薄膜,在室温下实现了蓝光电致发光[28]。然而,上述p型ZnO的研究工作尚未取得像GaN那样的突出成果,在实践上,伴随着人类能够发明出有着高度精密控制能力的成膜设备,p型GaN的研究已经取得了实用化进展,但高浓度p型GaN优质薄膜的生长仍是个难题。对ZnO来说,p型掺杂的研究进展则相对慢得多,高稳定性、高载流子浓度的p型材料制备仍然是个世界性难题。
总体来说,与第一代半导体材料(Si、Ge)的发展历程不同,第三代半导体材料的理论研究实际上落后于实验探索。一个典型的特征是当前生长宽禁带半导体材料薄膜的设备控制精度远高于20世纪50年代以硅基材料为主导时期所使用的仪器,然而,对于诸如ZnO、GaN等第三代半导体材料来说,虽然经过近20年的艰苦努力,依然没有找到像Si材料一样普适性的p型与n型掺杂方法,该方法应包含半导体学家所提出的理论和材料学家所能实现的实操性技术手段。换句话来说,当前缺乏一种针对宽禁带半导体(或化合物型半导体)的普适性载流子调控理论,这一理论必须同时为半导体学家和材料学家所理解,而正是这一理论的缺失限制了GaN和ZnO在光电子领域发挥更大的作用。
分析历史,可以找到材料发展的一些共通性规律:很多材料在最初被看好的领域往往很难迅速找到其实际应用。但是正是由于这种“被看好”,牵引了材料制备技术的提高,使得高质量材料不断出现,这些高质量材料往往在一些其他未被注意到的领域发挥出不可替代的独特作用。ZnO材料的发展正是这样的一个典型:近来,ZnO在高能射线探测领域的发展动向十分值得关注。在可获得优质ZnO单晶的基础上,人们偶然发现它具有非常短的辐射发光衰减时间(小于1 ns),远小于传统闪烁体材料NaI∶Tl(60 ns),因此,ZnO在超快辐射信号检测方面已经成为一种非常具有前景的候选材料。此外,大尺寸、高迁移率、低载流子浓度的ZnO单晶在可见和红外波段有着很高的透过率,其导电性又使得大多数无线电波无法透过,这些特性使ZnO在特殊领域中红外光电窗口方面的应用得到了很大的关注。
下面,本文将在第1部分第1小节试图对ZnO在介电压电领域的应用进行总结性地介绍与评价,第2小节将试图对ZnO在半导体领域的研究探索进行简要描述与分析。余下的第2、第3、第4和第5部分将主要结合本组的工作进行阐述:第2部分主要对ZnO晶体水热生长进行总结;第3部分将以ZnO为例对化合物型半导体的载流子调控普适性理论进行详细地介绍;第4部分将分别以ZnO n型材料的成功制备、p型材料的尝试制备和高阻材料的初步制备为例,讲述该理论在ZnO中的具体实施措施;第5部分还将会对ZnO在闪烁体领域以及电磁屏蔽中红外透明窗口领域的应用作初步总结。希望本文的工作可以为从事相关研究的学者提供参考与借鉴。
1 ZnO在介电压电和半导体领域的探索
1.1 ZnO在介电压电领域的研究探索
六方纤锌矿结构的ZnO单晶,无对称中心且具有c轴极性轴,因此一定是自发极化的压电晶体。自发极化的晶体两端产生电性相反的束缚电荷,因此在真空无吸附条件下,ZnO自身应具有很强的极性。然而,处于大气环境中的ZnO两极性面将吸附一层与束缚电荷符号相反的自由电荷,这层来自外界的自由电荷屏蔽了内极化强度,以保持晶体各局域呈基本电中性;同时,ZnO还通过缺失部分表面原子来维持晶格稳定性,这也使得内极化强度的屏蔽效应进一步增强。可以看到,ZnO的极化特征与所处环境密切相关,这也是不同研究者在使用不同实验条件下制备的ZnO(尤其是纳米级材料)出现许多奇特且难以解释现象的本质原因。
在沿着c轴方向外力作用下,晶体内部的固有偶极矩将发生最大地变化,极化强度也随之改变,产生充放电现象,这就是ZnO正压电效应的由来。反之,当在晶体表面施加一个电场后,ZnO会产生相应的形变,这一过程被称为逆压电效应。ZnO良好的压电特性在人们解析了它的晶体结构后就立即被预测出来。但由于它是极性轴引起的自发极化(非畴化极化)晶体,晶体的内部结构是固化的,不可以通过畴化作用使得极化方向改变,因此合成晶粒取向不一致的陶瓷ZnO将无法通过畴化极化作用实现压电效应的外展体现。所以ZnO与钛酸钡(BaTiO3)这类压电陶瓷材料不同,必须获得质量良好的单晶才能实现其压电应用价值。如前所述,人们过去尝试了多种晶体生长工艺来制备ZnO单晶,但出乎预料的是,所制备的ZnO单晶与陶瓷不同,竟然出现了导电特性,而这一发现如果不引入量子力学的固体能带论是无法被当时的介电材料物理学家所理解的。于是,ZnO这一未知的导电性导致了它虽然具有高机电耦合系数(1.5%~1.7%)和低介电常数(8.66),但其内部自由电子的屏蔽效应直接扼杀了它在低频机电耦合领域应用的可能。
在单晶生长技术发展的同时,ZnO薄膜生长也取得了巨大的进步,人们发现在一些特殊条件下可以制得与单晶不同的高电阻率ZnO薄膜[29],如果薄膜中自由电子对高频电场的响应慢于外界的控制频率,依然可以发挥出ZnO优异的压电性能,因此它在高频机电耦合领域,尤其是作为声表面波(SAW)器件材料的研究仍在持续进行中。由于现代通信技术向着更高频的趋势发展,能够在甚高频下对频谱进行滤波的高频大功率SAW器件成为这一领域拓展应用的关键。在甚高频滤波和分辨领域,频谱分离的能力(即信息传递能力)完全取决于材料压电系数的大小,故ZnO凭借其较大的压电系数在这一领域中受到一定程度的重视,相关的研究目前仍处于探索之中。与LiNbO3和LiTaO3等已在SAW器件上使用的压电材料相比,ZnO还具有良好的抗辐照能力,因此可能在航空航天或核反应等恶劣的工作环境中具有独特的应用优势。
如本小节第一段所述,ZnO的特性与其尺寸和表面状态有着极其密切的联系。虽然表面的吸附状态、表面缺失的部分原子等因素是极难分析和探测的,但它对内极化强度的影响却是巨大的,因此可以预见,纳米尺度的ZnO将产生许多有趣的现象。最先关注到这些现象的是以王中林为代表的研究人员。他们首次利用纳米材料的压电性能来富集电荷,研制出了基于ZnO纳米线阵列的纳米发电机,实现了机械能到电能的转化[30]。这一开创性的工作被认为在能源采集、微纳机电系统、纳米机器人和人机交互等多个新兴技术领域具有巨大的应用潜力,吸引了许多国内外科研小组纷纷投入到纳米压电材料的合成以及纳米发电机的研究工作中。截至目前,科研人员已制备出上百种不同形貌的ZnO纳米结构[31-44],并研发出一系列性能不断优化的纳米发动机[45-49]。总的来说,这类工作具有研究方法新颖,同时深入探索微观尺度材料性质的特点,因此在很长一段时间内都有着较高的研究热度。该工作的另一个特点是实现了机械能在没有磁场介入的情况下向电能的转化,是一种新颖的机械能-电能转化方式。然而,在以法拉第发电机为原型的现代发电机已可将99%的机械能完全转化为电能的情况下,上述纳米发电机的能源采集模式与这类通过电磁感应将机械能转化为电能的方式相比,在结构、成本和转换效率上基本不占优势。从总体上看,这一系列工作只有在纳米发电机微能源采集等特殊领域才可能得到真正应用,但是这是否为唯一性、排他性的最优能源采集方案尚未得到充分证实,目前,纳米ZnO的相关工作仍停留在基础研究探索阶段,在实际应用中并未取得实质性进展。
1.2 ZnO在半导体领域的研究探索
半导体材料与技术的发展推动着现代信息社会的进步,当人们对信息存储、传输与处理的要求越来越高时,传统的第一、二代半导体材料(如Si、Ge、InP、GaAs等)已无法满足短波长光电子领域和高频高功率微电子领域的应用需求。20世纪90年代初,在半导体照明领域的需求牵引下,氮化镓(GaN)p型掺杂首先取得了重大突破,经过十几年的研究与开发,成功研制出了高效蓝绿光发光二极管和蓝光半导体激光器[50],标志着第三代半导体材料的兴起。ZnO是继GaN取得巨大成功后人们曾寄予厚望的新型Ⅱ-Ⅵ族直接带隙宽禁带半导体材料,由于其原料成本远低于GaN,且室温禁带宽度为3.37 eV,对应近边发射峰(NBE)为368 nm的近紫外光,因此有望实现可见、紫外荧光和激光发射,并研制出半导体型短波长和超短波长光电子器件。ZnO另一个突出特点是具有高达60 meV 的激子束缚能,故它在室温下非常稳定、不易被热激发,激子发光所需的激射阈值更低(240 kW/cm2),效率更高[25,51]。另外,ZnO在室温下的紫外受激发射还具有较高的光学增益(320 cm-1)[52]、高的能量转换效率以及高的光响应度[53],且单色性很好,故其在紫外和蓝光光电器件的应用上比GaN和SiC等其他半导体材料更具优势。除此之外,ZnO还具有高击穿电压、耐高温和耐辐照等优异特性,因此在更高电压、频率、温度和恶劣辐射环境下工作的微电子器件中具有广阔的应用前景。
对于ZnO在半导体领域的应用来说,制备优质的ZnO薄膜是实现其器件制造与应用的基础。早期由于对薄膜生长的控制能力弱,很难制得高质量ZnO薄膜,也无从在此之上实现载流子浓度的自由调控,从而使其实际应用受到限制。因此,人们致力于发展各种高精度控制的薄膜生长设备。当前常用的薄膜生长技术有:磁控溅射(MS)、脉冲激光沉积(PLD)、分子束外延(MBE)以及金属有机化合物气相沉积(MOCVD)等。其中,MOCVD是目前制造大多数商业化光电器件最为广泛的外延生长技术[54-56],它容易实现任意组分比的合成、原子级厚度精确控制、灵活切换气源以及大面积产业化制备。这些优势在第二代半导体(InP、GaAs)以及第三代半导体GaN领域中都起到了关键性作用,使得MOCVD技术成为解决宽禁带半导体及相关器件结构等需求问题的重要工具。从技术角度上来说,ZnO薄膜也必须使用MOCVD或类似的设备才能获得最终的广泛应用。可以说,通过MOCVD制备ZnO高质量薄膜的科学和技术问题目前已经基本解决[57],然而ZnO应用的另一瓶颈问题:载流子的自由调控,并未像InP和GaAs那样能够通过不断地工艺探索得到解决。这一点在第三代半导体GaN材料上也有一定的体现,制备p型GaN所需Mg的掺杂量往往远高于理论预测,而且高载流子浓度、高迁移率的p型GaN薄膜也仍然未被成功制备出来。
可以看到,第三代半导体的实践探索领先于理论,具体体现在:大多数的研究者忙于探索MOCVD在宽禁带半导体的实践工艺,而忽略了半导体工艺和理论研究的结合;人们过去在InP、GaAs、GaN研究领域所积累的经验与提出的生长理论均为解释性结论,并不具备预测能力;对于如何通过调控生长环境获得目标载流子浓度的半导体材料只提出了工艺性总结,并没有一套普适性理论。因此,当人们试图完全照搬已有的InP、GaAs、GaN等材料的成功经验用MOCVD来生长ZnO薄膜时就遇到了巨大的困难。
对ZnO微观结构的研究,人们也做了很多有意义的工作,可以说正是因为ZnO在通过多种尝试方法后仍未能实现稳定的p型掺杂,人们对其微观分析的基础研究反而更加重视,试图发展各种精细光谱技术,并结合材料生长,对半导体材料中的能带结构微变化、声子结构和其他能量结构进行细致的研究,找到工艺条件和对应微观结构之间的经验性关联,最终得到实现稳定p型掺杂的可行性方案。ZnO常用的光谱研究方法有光致发光(PL)、红外(IF)和拉曼(Raman)等,其中,对ZnO电子结构的共识性认识通常是通过低温(10 K)下的PL光谱(见图1)分析得到的。低温发射可大致分为380 nm附近的紫外尖峰发射和520 nm附近的绿光宽峰发射,(1)在紫外波段,自由激子发射峰为3.377 eV,其他比主峰能量低0.018~0.024 eV的系列发射峰分别归因于束缚在电离和中性施主上的激子发射[58-60],还有一些杂质所导致的激子发射的归因仍存有诸多争议;(2)在绿光波段,发射峰一般认为与ZnO中各种深能级缺陷有关,例如氧空位(VO)、氧间隙(Oi)、锌空位(VZn)、锌间隙(Zni)和氧替位锌(OZn)等,但即便是在甚低温下其光谱仍是较宽的,其排他性归因和详细机理也并不清晰,还有待进一步的研究。

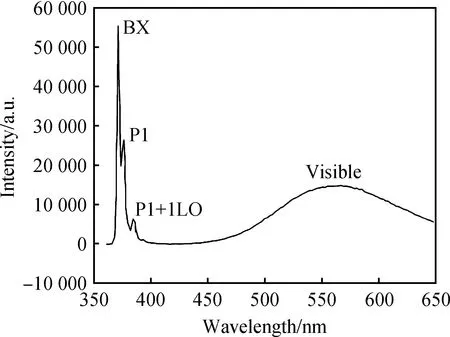
图1 典型的ZnO薄膜低温光致发光谱(10 K)[58]Fig.1 Typical photoluminescence spectrum of ZnO thin film at low temperature(10 K)[58]

图2 典型的ZnO拉曼光谱[68]Fig.2 Typical Raman spectra of ZnO thin film[68]

表1 在布里渊区中心ZnO拉曼与红外光谱测试的声子模频率[67]Table 1 Phonon mode frequencies of wurtzite ZnO at the center of the Brillouin zone obtained from infrared spectroscopic ellipsometry IRSE and RS measurements in comparison with theoretical predictions[67]
ZnO中的背景载流子浓度问题一直是一个非常受关注的问题,几乎所有的学者都把这一问题归因于ZnO中不可控制的H元素的出现与占位。但是由于导致产生10-17cm-3背景载流子浓度的H相对于本体元素只是百万分之一的含量,很难进行可靠的分析并明确指认出H缺陷的具体状态。尤其是对于薄膜材料来说,非平衡态下的生长可能出现种类众多、信号复杂且稳定性差的H缺陷,增加了指认的难度。近期,本团队利用在平衡态下生长的ZnO单晶中H缺陷种类单一、稳定性高所带来的可指认性,采用NMR技术和红外技术相结合的办法首次展开了对微量缺陷的研究[69]。研究结果揭示了1种Zn空位可以被3个H同时替代的稳定缺陷结构,这一稳定缺陷结构可以很好地解释背景载流子浓度产生的原因。
可以看到,上述ZnO光谱和核磁共振谱所揭示的微观问题已经非常深入,有不少研究结论已经得到公认。然而,即使在光谱认识清晰以及精确控制技术成熟的情况下,仍然没能成功制备出高空穴浓度、高空穴迁移率和高热力学稳定性的p型ZnO,这使得人们不得不重新审视过去的研究历程与研究范式选用是否合理。当前ZnO的p型掺杂工作通常只是简单地沿用Si、Ge或GaAs材料的掺杂范式,即先摸索材料制备工艺,若能成功制得目标材料则做进一步微观缺陷分析,用所得信息来解释半导体材料核心参数的形成。之后,通过不断优化的办法反复制备材料及器件,形成工艺和微观特性之间的经验性规律,如此循环往复,最终建立起半导体材料核心参数(载流子浓度和迁移率)与生长工艺之间的关联,并固化下来。上述的研究范式,中间缺失了重要的一环,即没有揭示生长工艺(生长热力学条件)、缺陷形成的热力学条件以及核心参数之间的本质关联。本课题组经过对ZnO多年的研究,首先指出了上述ZnO掺杂领域默认沿用第一代半导体掺杂思路这一前提性假设的问题所在。在此基础上,进一步分析了前人所使用的各种掺杂方法的优劣性,并指出了这些方法无法同时实现高载流子浓度、高迁移率和高热稳定性的主要原因,提出了一种实现稳定p型掺杂所必需的宽禁带半导体载流子调控的普适性方法,这将在本文的第3部分进行详细阐述。
2 氧化锌的单晶生长
2.1 水热生长方法
“水热”这一术语大约出现在150年前,原本在地质学中用于描述地壳在温度和压力联合作用下的自然过程。常见的自然水晶即是通过地热过程将硅石(SiO2)溶解并缓慢结晶形成,人们通过模仿这一过程发展了人造水晶生长技术。当前的人造水晶生长技术已经非常成熟,其大型高压水热釜能实现商业化生长直径为250~500 mm的水晶,这大大降低了人工水晶的成本,使得人工水晶不仅可以作为一般的光学材料,甚至可以用作室内装饰用品。
根据材料的高压溶解特性,可以采用不同的水热结晶生长方法(温差法、升降温法等)。对于ZnO来说,由于其溶解度系数较小,因此考虑使用温差法。温差水热结晶法的工艺装置一般使用如图3所示的高压釜[70],整个生长过程在耐高温高压抗腐蚀的特制立式密封容器内进行。一般来说,培养晶体的原料放在高压釜温度较高的下部,籽晶悬挂在温度较低的上部,并采用水溶液作为反应介质。传统水热法一般使用超临界状态的水,和常温常压的水相比,超临界水的氢离子解离能力强、密度低、极性低且黏滞性低,对溶质的溶解能力更强。尽管如此,超临界水的溶解能力仍不足以溶解原料,故需在釜内填充一定容量和浓度的矿化剂溶液作为溶剂,将原本在100 ℃下难溶于水的氧化物在溶解区溶解形成饱和溶液。当容器内的溶液由于上下部之间的温差而产生对流时,高温区的饱和溶液被输运到低温区,从而形成过饱和状态,析出使籽晶生长。在籽晶上析出部分溶质的溶液冷却后流回下部,变得不饱和,可再溶解原料,如此循环往复,使籽晶不断长大。

图3 ZnO单晶水热生长系统示意图Fig.3 Scheme of the hydrothermal reactor for ZnO single crystals
如前所述,晶体水热生长方法是一种低温、近热力学平衡态下的生长,且晶体与周围溶液的温差可控制至0.01 ℃,因而在这种环境下生长所获得的单晶晶格完整性高、本征缺陷浓度低、热应力小。这一生长技术对如ZnO这类的半导体型晶体,即对百万分之一含量的杂质和缺陷十分敏感的晶体来说,是尤为有利的。同时,由于已经有了发展成熟的工业级人造水晶生长的水热釜及密封技术,在此基础上去实行ZnO单晶生长工业转化的可行性也是很高的。因而,在ZnO生长的基本科学问题得到解决后,迅速地实现商业化批量生长是非常可行的,其生长成本甚至可以迅速下降到水晶级别。
2.2 纯ZnO晶体水热生长
晶体水热生长需要选取合适的矿化剂溶液,使其在一定的温度压力条件下具有足够大的溶解度和溶解温度系数。传统ZnO单晶生长法常用的水热矿化剂有LiOH、NaOH、KOH、Li2CO3和H2O2[71-75],其中,混合矿化剂LiOH和KOH被视为较好的生长溶剂。在KOH溶液中,ZnO生长速度过快导致难以控制晶体生长速度,但加入LiOH可以降低结晶速度,进而提高晶体生长质量。利用水热法在碱溶液(LiOH、KOH)体系生长ZnO的研究是比较深入的,其生长机理被认为是体系中ZnO与碱溶液存在以下的平衡反应:
ZnO+2MOH+H2OM2Zn(OH)4
(1)
其中,M=Li、Na、K等,MOH和M2Zn(OH)4均可溶于水,而ZnO不溶于水,M2Zn(OH)4为中间化合物。当温度较高时,反应向右进行使得ZnO溶于矿化剂形成M2Zn(OH)4的饱和溶液。饱和溶液随着对流进入温度较低的生长区,这时平衡反应向左进行,过饱和溶液在籽晶上析出并结晶。
人们对ZnO晶体水热生长的研究从很早就开始了,Kolb和Laudise等于1960年首次提出将上述LiOH和KOH混合矿化剂用于ZnO单晶水热生长[71]。2006年,日本的Ehrentraut等使用相同的矿化剂,通过直径为200 mm,长为3 000 mm的高压水热釜获得了直径为3英寸(7.62 cm)的ZnO单晶[76];俄罗斯的学者在2008年生长出了尺寸为76 mm的ZnO[77];我国桂林矿产地质研究院的相关学者沿用相同的水热矿化剂在同年生长得到了尺寸约为40 mm的ZnO[78]。以上的传统水热法所面临的共同问题是:晶体需要在贵金属(Au、Pt)内衬中进行生长,生长成本十分高昂,同时,由于使用了碱性的矿化剂,K+和Li+会不可避免地掺入ZnO晶格,可能会造成晶体迁移率难以提高,仅在约80 cm2/(V·s)附近的范围,无法在一些要求高电导率且高红外透过率的领域(如中红外透明导电窗口)使用。
为了使晶体生长成本大幅降低并进一步提高晶体迁移率,本团队在初期通过对ZnO水热环境的热力学基础研究,找到了一种新型的复合矿化剂。这一新型矿化剂的优势在于大大降低了杂质离子在溶液中的化学势,使其远低于在ZnO晶格中的化学势,因而杂质离子在热力学上倾向于留在生长溶液中而不进入ZnO晶格,这样就无须使用贵金属内衬,仍然可以获得比传统矿化剂下生长的ZnO单晶更高的迁移率(高达300 cm2/(V·s))。在此基础上,团队经过持续15年的努力,根据新型矿化剂的需求不断改造并放大ZnO单晶的生长设备,并在实际生长中成功绕过了杂相生长的温区,最终在ZnO单晶水热生长上取得了较大的突破。当前ZnO单晶的尺寸已到了100 mm,由于生长的设备可以完全自主设计和制造,因此,形成了从设备制造到生长工艺都完全自主的一套水热生长技术。
水热生长设备包括高压釜、加热炉和控温设备。其中,高压釜是水热晶体生长的关键设备,晶体生长的效果与它密切相关,本团队的水热生长设备研制经历了口径20 mm、30 mm、66 mm和90 mm四个阶段。在这四个阶段中,设备研制基本思路仍是遵循传统高压釜的设计规则,即高压釜口径与长度之比需达到1∶20,甚至更小。在此设计思路下,ZnO单晶尺寸依赖于水热设备的大小,而随着高压釜的放大,其制备困难程度也将成倍增加。可以看到,当前水热设备设计方案下所获得的单晶尺寸已逐渐趋于极限。因此,出于对更大尺寸单晶的需求,还拟设计其他新型水热釜生长设备,希望能够突破传统水热釜口径与长度比例为1∶20的限制。采用新的对流模式,以期为解决大尺寸ZnO单晶生长的问题提供新思路。
使用以上自主设计制造的水热生长设备,本课题组摸索出了大尺寸优质ZnO单晶的稳定生长工艺[70],以口径为66 mm的高压釜为例进行简单的介绍。图3为水热法生长ZnO单晶的反应体系示意图,生长是在一个内衬口径为66 mm,高度为1 000 mm,内衬容积为3 400 mL的高压釜内衬中进行的。高压釜釜体采用高强度镍铬合金制成,内衬材料和籽晶架等均采用廉价的非贵金属材料。把数量超过100颗的ZnO籽晶片悬挂在籽晶架上,然后把一定浓度的新型矿化剂溶液倒入高压内衬内。通过调节溶液的pH值和外加络合剂,改变某些金属元素杂质在溶液中的化学势,以及ZnO晶体中VO的化学势,使得新型矿化剂同时具有抑制杂质元素进入晶格以及对晶格中的氧缺陷控制的能力。在高压釜密封后,放入生长炉,通过精确控制升温速率,保持温度场稳定的方法减少自发成核,并保证溶解区和生长区温度差控制在15~35 ℃。内衬液体填充度约为70%~90%,生长压力可以达到50~100 MPa,晶体生长周期约为30~100 d。
通过上述晶体生长工艺,可重复性获得直径2英寸(5.08 cm)ZnO单晶(见图4(a))(在更大的釜体,如90 mm以及目前正处于研制中的125 mm水热釜中,已经成功生长出了尺寸为4英寸的ZnO单晶),对其物理化学性质进行了一系列表征分析。新型水热法生长的ZnO单晶载流子浓度为5.3×1016cm-3,室温下载流子的迁移率高达296 cm2·V-1·s-1,与材料本征值相当(300 cm2·V-1·s-1),在79 K下其迁移率可达最高值1 360 cm2·V-1·s-1[4]。图4(b)是经过化学机械抛光(CMP)后的ZnO单晶以(002)作为发射面的X射线双晶摇摆曲线[70],其半峰宽(FWHM)为18 arcsec,而Ehrentraut等使用传统水热法生长所得ZnO单晶FWHM为19~30 arcsec[76],说明新型水热法可以获得与传统水热法结晶质量相当的ZnO单晶。同时,新型水热法所得ZnO单晶FWHM远低于压力熔体法(49 arcsec)[17]和化学气相传输法(30 arcsec)[79],表明水热法由于生长温度低和生长过程接近平衡态的优势,可以获取结晶质量高且稳定的ZnO单晶。图4(c)为两个样品的紫外可见透射光谱[70],可以看到,新型水热法生长的ZnO单晶透射率比传统水热法样品高,且没有明显的可见光吸收峰,这与新型水热法所得晶体接近无色的特征相吻合。图4(d)为10 K温度下的新型水热法和传统水热法样品的PL谱图[70],其近边发射峰为3.359 eV,可判断其为束缚激子发射峰,没有发现与本征缺陷有关的黄绿带,而传统水热法样品近边峰为3.373 eV,为自由激子发射峰,可观测到黄绿带发射。以上物理化学性质分析结果表明利用新型水热法生长ZnO单晶所得晶体质量高、本征缺陷浓度低,在实现商业化应用上具有巨大的潜力。

图4 (a)新型水热法生长所得纯ZnO单晶实物图[80];本课题组(SYSU)与美国MTI的ZnO单晶(b)X射线双晶摇摆曲线[70]、(c)紫外可见透射光谱对比图[70]; (d)本课题组(SYSU)与日本TEW ZnO单晶低温光致发光谱图[70]Fig.4 (a) Photograph of native ZnO single crystal[80]; (b) X-ray rocking curves for (002) reflection[70] and (c) optical transmittance spectra of Sun yat-sen university(SYSU) and MTI ZnO single crystals[70];(d) PL spectra of SYSU ZnO and TEW ZnO wafers[70]
2.3 ZnO∶Ga晶体水热生长
近年来,Ga掺杂的ZnO(GZO)材料作为一种新型材料受到了人们的广泛关注。通常认为ⅢA族元素占据ZnO中的Zn位点充当浅能级施主,产生高的自由电子密度,可作为透明导电电极。在ⅢA族的所有元素中,Ga因其与Zn相似的原子半径被认为是获得高质量n型ZnO的最佳掺杂元素。GZO理论上具有小的晶格畸变、高的化学稳定性和高的Ga元素固溶度,有传统透明导电材料Sn∶In2O3(ITO)同样的高导电特性,且具有低成本、无毒、热力学稳定等优点,因此,GZO有望取代ITO成为透明导电电极的新型材料。除此之外,GZO因其在α离子辐照下具有ns级以下的发光衰减时间,且化学和机械性能较稳定、抗辐射能力强,从而在α射线和中子射线探测以及超快闪烁体领域有着潜在应用。
然而,由于高结晶度的Ga重掺ZnO单晶材料获取难度较大,现阶段的大部分科学问题研究都是以ZnO∶Ga薄膜多晶材料作为研究对象。在成膜过程中,处于非平衡态生长条件下的薄膜缺陷(表面态、晶界、本征缺陷、第二相、团簇)是不可控制的,所制得的薄膜通常热力学不稳定、载流子迁移率较低、Ga处于不稳定占据态。薄膜的缺陷问题给分析Ga在ZnO晶格中行为(占位情况、化学势、形成能、电离能等物理信息等)增加了很多不确定因素,加大了研究难度。而基于高质量单晶的研究,可以为相关物理机制探索提供高度可信和可重复性的数据,从而降低一些关键性基础科学问题研究的难度。因此,用单晶来研究Ga的掺杂,所得的数据更为可靠,与纯晶体对比后,能够得到准确的Ga掺杂后所产生的能级信息和能带状况,进而分析缺陷的各种物理机制。
在ZnO单晶生长和半导体物理机制研究工作的基础上,本课题组采用了类似的水热设备在基本相同的生长条件下生长ZnO∶Ga单晶[81]。以口径为30 mm,高度为500 mm,容积为320 mL的不锈钢高压釜为例,原料由一定比例的ZnO和Ga2O3粉末烧结而成,矿化剂沿用生长ZnO单晶所使用的新型复合水热矿化剂,并根据具体需求进行了调整。生长时,将新型水热矿化剂倒入高压釜,再将高压釜竖直放入加热炉内,并控制晶体生长温度稳定。有趣的是,GZO单晶的生长速度比纯ZnO单晶快得多,因而其生长时间可以节省约 20~50 d。
采用与纯ZnO单晶相同的水热生长方案可以获得尺寸为2英寸(5.08 cm)的Ga重掺杂ZnO大尺寸单晶(见图5(a))[82],之后,对生长所得的GZO单晶进行了一系列物理化学性质表征,其表征结果如下:使用电感耦合等离子质谱(ICP-MS)测试了样品中的Ga含量,证实了Ga已经掺入了ZnO晶格内,且Ga的浓度为2.19×1019cm-3。图5(b)展示了GZO单晶的X射线双晶摇摆曲线[81],其FWHM为46.4 arcsec,远低于GZO多晶薄膜的FWHM(612~1 368 arcsec),表明通过新型水热生长所得的GZO单晶具有良好的晶格完整性。为了研究GZO单晶的自由载流子(电子)吸收散射机制,对样品测试得到如图5(c)所示的紫外可见近红外透射光谱[81],可以看到,由于自由电子光吸收,GZO体现出对可见光和近红外光的强吸收。对吸光度A和波长λ按照公式(2)进行拟合:
A=kλα
(2)
式中,k为拟合系数。得到吸收系数α=2.5,表明电子在导带内跃迁借助于电离杂质(Ga3+)散射。同时观测到了吸收边红移现象,可能原因是电子导带-带尾态的跃迁。图5(d)为GZO单晶的X射线粉末衍射图谱[81],图谱中没有发现其他杂质相,通过进一步对衍射图谱Rietveld的晶格常数解析,发现GZO晶格常数比a/b仅减小了0.044%,c则基本保持不变,表明掺杂元素Ga为替位取代。GZO单晶的电子浓度为1.07×1019cm-3,约为未掺杂ZnO单晶的250倍。室温下的电子迁移率为81.5 cm2/(V·s),远高于目前所报道的GZO薄膜迁移率(25~41.5 cm2/(V·s))。不同于薄膜材料,在1 000 ℃空气气氛退火后的GZO单晶电学性能几乎不变(见表2)[81],这说明Ga引入的自由电子浓度具有高度热稳定性。总体来说,本课题组通过新型水热法生长的Ga重掺ZnO单晶具有良好的晶格完整性、极高的热稳定性、高自由电子浓度和迁移率,有利于对ZnO材料基础物理化学性质和半导体性质的研究,在透明导电电极和超快闪烁体领域有着广阔的应用前景。
3 ZnO的载流子自由调控
在大多数人看来,金属、半导体和绝缘体是三种不同的材料,它们分别对应的载流子浓度为>1022、1014~1019、<1012cm-3。这样的分类容易被大多数学者所理解,但实际上可能导致对物质真实本质的误解。根据量子力学所发展出的固体能带论,绝缘体和半导体有着完全等同的电子结构特征,即:有着全满型能带结构的材料都是半导体,而有着半满型能带结构的材料都是金属。换句话说,只有金属和半导体电子结构,没有独立的“绝缘体”电子结构。理论上,只要进行合适的掺杂,由绝缘体转化过来的具有1014~1019cm-3载流子浓度的半导体就可被制造出来。然而,在主导研究 Ge、Si、GaAs这几种典型半导体材料后,尝试将其他绝缘体转变成半导体在很长一段时间里都是边缘性研究课题。直到1990年左右,对短波长发光器件以及高频高压器件的发展需求,研究人员开始重新关注一些原本被认为是“绝缘体”的材料向半导体的转变,例如,现被宣称是宽禁带半导体的GaN、SiC、ZnO和Ga2O3等。然而,对宽禁带半导体载流子浓度进行自由调控一直是一项艰巨任务。尽管研究人员拥有比50年代复杂得多的精密控制设备,但经过约30年的艰苦努力,仍无法实现宽禁带半导体材料的完全载流子自由调控。

图5 新型水热法生长的ZnO∶Ga单晶(a)实物图[80]、(b)X射线双晶摇摆曲线[4]、(c)与纯ZnO单晶的室温紫外可见近红外透射光谱对比图[81]、(d)X射线粉末衍射图[81]Fig.5 (a) Photograph[80] and (b) X-ray rocking curve[4] for (002) reflection of gallium-doped ZnO single crystal; (c) room temperature(RT) optical transmittance spectra of pure ZnO and as-grown GZO crystals[81]; (d) X-ray powder diffraction pattern of the as-grown GZO[81]

表2 未掺杂ZnO单晶、GZO单晶、退火后GZO单晶的室温电学性能[81]Table 2 Room temperature electrical performance of pure ZnO, as-grown GZO and annealed GZO crystals[81]
上述的困境可能是由于半导体物理学家和材料学家都缺乏全面的认识。作为半导体学科的基础,能带理论相对准确地描述了有着周期性晶态结构物质的现有电子状态,但并不能反映其形成过程;而材料学的范式则更加准确地描述了周期性结构的形成过程,对周期性结构形成之前组成单元的电子状态(局域电子态)有着较为正确的认识,但并不能正确描述形成周期性结构后的电子状态(布洛赫波离域电子态)。一个形象的描述是,半导体物理学家类似于设计人员,确切地知道由各部分组成的集成结构有着怎样的预期功能,以及预期功能产生于集成结构的哪种物理机制。材料科学家是建筑师,他们所能理解的是如何用一块一块的单体材料(如分子、原子)去构建一个总体结构,但对形成集成结构后能产生的预期功能,以及这一功能产生的机制是缺乏理解的。半导体物理学家和材料科学家之间缺乏通用的学术术语,这一学术上的不足在第一代半导体材料制备的过程中,还未明确地突显出来。然而,在宽禁带半导体领域,要想实现载流子浓度的自由调控一定要找到一种能够让半导体物理学家和材料科学家都能理解的共同学术术语。
对于如上的判断,下面用Si材料的发展历程为例进行说明。本文尝试概括了半导体理论和工艺之间相互协调发展,形成较为固化的材料研究范式的过程:首先是半导体物理学家通过能带论和电、光参数的实验及分析研究,得到Si材料是一个有着1.12 eV、非直接带隙的半导体材料。然后,材料学家通过实践研究发现,尽管Si的熔点较高,但它具有金刚石结构,因此对除B元素以外的其他杂质均具有很强的自排杂作用。这满足了半导体材料需要高纯本征体的基本要求,在此基础上,半导体学家和材料学家协同工作,尝试在高纯Si单晶中掺入各种元素,发现B、P元素的掺杂均非常容易控制,且其固溶体的浓度控制也非常容易;之后,半导体学家通过理论和实验研究确认了B和P在Si晶格中最稳定且最容易出现的赋存状态是替位,而且BSi和PSi分别为浅受主和浅施主能级。至此,就没有必要进一步分析B和P在Si中其他可能的存在形式,以及替位杂质原子的稳定热力学边界,而只要直接提出半导体材料的功能“需求”(载流子浓度的需求,即等效于BSi、PSi的浓度需求)和材料制备工艺(即需要多少量的P和B杂质前驱体在什么温度下进行制备)之间的经验性联系。换句话说,在这里,半导体学家已经形成了一个仅在Si材料下适用的简单认知范式(见图6):即只要杂质原子出现,就一定会进入材料并出现在理论希望出现的晶格占位上。如果宏观物理特性和微观结构表明杂质原子并非出现在预测的位置,通过“炒菜式”的工艺调整也一定能使杂质原子进入理论所期望的位置。

图6 Si半导体材料载流子调控认识的简化范式Fig.6 Simplified paradigm of carrier concentration regulation in Si
如上简化范式的成功基础在于单质半导体单晶Si中掺杂元素B和P的热力学状态非常单一,但实际上,正确而全面的认知范式应该如图7所示, 半导体学家提出所需要的微观结构(即杂质和缺陷),材料学家则根据热力学原理来研究这一缺陷结构的热力学稳定性及动力学形成过程,然后根据所找到的热、动力学条件来设计对应的设备用于制备目标材料,最后进行工艺改进。而不是像Si材料制备的简化范式那样,在通用的制造设备上,直接通过工艺改进实现所需要的缺陷结构。
如前所述,宽禁带半导体材料已经在如图6所示的简化范式指导下研究了近30年,却一直未能实现实质性的载流子浓度自由调控。因此,本课题组认为现在应该倡导使用如图7所示的全面研究范式来重新指导研究,让人们更加关注缺陷热力学问题和动力学形成过程等。一种新的范式的引入,实际上也急切地呼唤出现一种新的理论,这种新理论应该包含同时能被半导体物理学家和材料学家所共同理解的学术术语。或者换句话说,这个理论能够对同一物理机制,分别使用半导体学家和材料学家两种语言来进行描述。在这样的理念指导下,本文根据15年来对ZnO单晶及其载流子浓度调控的实践研究和理论思考,逐渐形成了一个符合上述全面认知范式的化合物半导体载流子调控新理论规则[83],这一规则事实上不仅局限于ZnO材料,它的主要适用范围是离子型晶体结构的化合物半导体(包括氧化物、氮化物、氟化物等)。该理论可以被简单描述为:对于离子型化合物半导体来说,材料的p型和n型由其精细化学组分完整表达式唯一决定,当精细化学组分完整表达式确立后,掺杂和占位的具体微观结构不影响材料的最终导电类型,但会影响材料的载流子浓度和迁移率。下面将以ZnO为例对这一理论进行详细地解析。
3.1 理论规则的发现
众所周知,一个好的半导体材料,在实现载流子浓度自由调控的同时,还必须保证材料的高迁移率和高载流子浓度稳定性,而这在宽禁带半导体材料中是很难同时实现的,即使是在已经得到广泛使用的GaN中也并未完全实现。如前所述,宽禁带半导体的研究延续着上述Si材料的简单认知范式,具体表现在:首先考虑选择何种杂质进行替位才可以形成浅能级,而对浅能级如何形成,形成后是否稳定,以及是否伴生对材料结构的破坏从而造成迁移率的大幅下降等因素,总是放在第二步进行考虑。由于高迁移率和高热稳定性均是与材料科学更为密切相关的因素,本文提出,如果首先考虑如何形成具有高迁移率和高热稳定性的材料,将可能更加符合半导体材料制备科学本应有的全面范式,也可能会带来一个全新的宽禁带半导体材料的制备策略[83]。

图7 半导体材料载流子调控正确而全面的认识范式Fig.7 Correct and comprehensive paradigm of carrier concentration regulation in semiconductor materials
3.2 离子型晶体的热稳定性取决于阴离子晶格完整性
众所周知,一个离子型材料的热稳定性通常是与材料本身的晶格完整性密切相关的,即越完整的晶格其热稳定性越强。对于具有同样晶格能的材料来说,晶格排布愈完整,材料的热稳定性愈高,其各种相关的物理特性也愈加稳定。具体对于ZnO来说,它是一个典型的离子型化合物,通常的晶格形成理论认为阴离子有着较大的半径,而阳离子的半径较小,但阴离子的质量却远远小于阳离子。这样一种结构从材料学和晶体学的角度上来说,是由质量较小的阴离子构成晶格的“基本骨架”,而阳离子作为基本骨架的黏结剂,对晶格稳定性的贡献是较小的。换句话来说,可以将离子型的ZnO晶体结构形象地比喻成由相互排斥的阴离子 “气球”(O2-)构成晶格骨架,在骨架中嵌入具有黏合作用的阳离子“小木球”(Zn2+)。显然,在晶格内部局域缺少了少量的“小木球”仍能保持晶格的基本稳定,整个晶格的畸变也很小;而如果局域缺少了“气球”,就会导致大的晶格畸变(见图8)。所以,整个材料的热稳定性实际上取决于阴离子晶格完整性,若其遭到破坏,材料的载流子浓度热稳定性在极大概率上也将会出现变化。因此从材料制备的角度,必须预先给半导体载流子调控工艺设置一个“边界条件”,即任何为载流子浓度调控而进行的工艺调整必须时刻保证阴离子晶格的完整性[83]。

图8 ZnO晶格中阴、阳离子缺失示意图Fig.8 Scheme of the ZnO lattice in the absence of a cation (Zn2+) and an anion (O2-)
3.3 离子型晶体的高迁移率取决于阴离子晶格完整性
这一小节将说明:材料的高迁移率在化合物半导体中也与阴离子晶格完整性密切相关。从材料与晶体学角度来说,ZnO的晶格骨架是由阴离子(O2-)堆积而成。然而,从能带论的角度来说,ZnO价带顶的波函数主要由大量O的2s、2p轨道和少量Zn的4s、4p轨道线性组合而成(见图9)[84]。因此,一旦O原子缺失或者由此造成O晶格较大的畸变,在价带和导带中必然将产生一个较大宽度的势垒(或势阱),这一大的势垒/阱必然会形成有着较大散射作用的电子和空穴,将大大降低晶体的载流子迁移率(对空穴和电子均有较大影响)。根据前面的分析,阳离子的缺失对晶格畸变造成的影响很小。另外,Zn的4s、4p轨道主要参与ZnO中导带的构建,对价带的影响较小,因而Zn的缺失对电子的迁移率可能会有一定的影响,但对空穴的迁移率影响较小。在ZnO p型掺杂的研究主题中,对空穴的关注度显然高得多,因此,综上所述,为了实际材料的高迁移率,尤其是空穴的高迁移率,材料合成工艺的调整也必须在能够实现阴离子晶格完整“边界条件”下进行[83]。

图9 以ZnO为例说明分子轨道理论和半导体能带理论在动力学理论上是等同的Fig.9 ZnO is taken as an example to show that the molecular orbital theory and energy band theory are essentially the same
3.4 半导体学家和材料学家对物质的认知范式
能带论是一种离域态理论,是半导体学家认识物质的范式,它不去关注某种特定的晶体结构为何会形成、如何形成、以及形成后是否稳定,而是先将各类原子按照已经测得的晶体周期性结构进行排布,之后再将各原子轨道根据量子力学能带论的原则进行线性组合,从而形成各能带。能带形成后,再将原归属于各原子的所有电子按照形成能态的高低依次填入(能带论是单电子论,不考虑电子与电子之间的关联作用)。由于对各原子来说,内层电子轨道往往被紧束缚于原子核附近,参与线性组合的程度很低,因此,简化的能带论也可以进一步地被描述为:先将原子实(原子核+内层电子)按照已测定的晶格结构进行排布,然后价电子轨道线性组合,最终形成能带结构,之后,再将所有价电子按能态高低填入。为了简化描述,默认之后提到的能带均为原子实-价电子模型。总的来说,能带论能够准确地描述电子在周期性结构中的真实状态,但却完全回避了周期性物质能否形成、怎样形成,以及是否稳定等问题。另外,在设计能带中可能出现的缺陷时,能带论通常首先关注这一缺陷是浅能级还是深能级,而很少考虑这一缺陷是否热力学稳定、以及是否有动力学渠道让这一缺陷形成等问题。如前所述,半导体学家是设计师,他们知道需要设计出具有何种功能的建筑,却不知道用哪种“砖块”(或建筑单元)、用什么样的程序才能建这所“房子”。
然而,材料学家所关注的晶体学理论却恰恰从另一侧面来观察物质,它的思维范式是:首先考虑物质周期性结构如何形成,即用哪种“砖块”、按照何种“程序”来构成。例如,对离子型化合物来说,它通常近似地认为物质是由电负性相差较大的两种原子,先通过化学反应得失电子分别形成阴、阳离子(“建筑砖块”),然后阴、阳离子通过一些与几何因素(即离子半径)相关的规则(“组建程序”)堆积而成。阴、阳离子自身拥有的电子结构是一种局域态的电子结构,它由化学键理论中的原子轨道或分子轨道所决定。可以看到,晶体学的观点对理解、设计和合成材料是非常有帮助的,它往往能够预测一种周期性结构能否形成、怎样形成、以及形成后是否稳定等问题,同样也可以预测半导体所需要的缺陷结构能否形成、如何形成、以及形成后是否稳定等。晶体学理论在认识材料本征的真实电子状态却是十分不利的,它经常会误导研究者认为周期性结构中的价电子都是属于某一特定的原子或原子团。因此,仅用晶体学的理论,在本质上无法预测到半导体材料的存在,正如介绍部分所述,ZnO最初是被当作绝缘态压电材料来开展研究。事实上,任何一个周期性结构中的价电子(能带电子),其基本波函数都是布洛赫波,在整个晶格中出现的概率密度是处处相等的,并不属于特定的原子或原子基团。换句话说,材料学是建筑师,他知道使用哪种建筑单元、按怎样的程序来构建一所“房子”,却无法先验性地预测该“房子”会具有怎样的功能。
以上两段分析,实际上已经说明仅凭半导体学家的范式或材料学家的范式(就像前述的Si材料载流子调控的简化范式一样),不仅无法全面地理解半导体材料从设计、合成到特性展示的全过程,而且对新一代半导体材料的制备也造成了局限。因此,如前所述,人们非常急迫地寻求一种载流子调控全新的范式与理论,这一理论能够包含半导体学家所能理解的学术术语,同时也应包含材料学家所能理解的学术术语。换句话说,这一理论可以将能带论中的电子和空穴、施主和受主,与材料学中的“组件单元”(离子簇或离子)对应起来。下一小节将以ZnO为例试图实现这种认知范式的转化。
3.5 理解半导体中的能带、施主与电子、受主与空穴
在这一小节,本文将试图融合上一小节中能带离域理论和离子晶体局域态理论对同一物理图像不同侧面的观察和理解,以ZnO为例,具象化指出半导体中的能带、施主与电子、受主与空穴五个概念在晶体学中的对应“组件”。
3.5.1 对能带的理解
能带论的计算表明,ZnO中费米面两侧的能带是由Zn的4s、4p轨道和O的2s、2p轨道线性组合而成,其中导带的主要成分来源于Zn的4s、4p轨道,价带的主要成分来源于O的2s、2p轨道。对于一个有着n个Zn和n个O的固体,在线性组合之前,共有状态数16n个:8n个来源于Zn,8n个来源于O。量子力学的状态数守恒定律中,轨道的线性组合并不会改变总的状态数,故材料总的导带数和价带数也为16n个:8n个价带,8n个导带。对于原子实-价电子体系,Zn可以提供2n个价电子,O可以提供6n个价电子,价电子可以正好将8n个价带填满,所以本征的ZnO为满带结构,表现为绝缘体。
以上这一描述,实际上完全等效于材料学家(或化学家)也能接受的分子轨道理论:将一个拥有n个Zn和n个O(n约为1023量级)的宏观固态晶体看成一个“超大分子”,这个“超大分子”的分子轨道完全等同于半导体学中的能带(见图9)。其中,半导体中的价带即是能量较低的成键轨道,导带即是能量较高的反键轨道。理论上,成键轨道的波函数往往在两个原子之间有着较高的概率密度,体现了相对“局域”的性质;而反键轨道的波函数往往是在原子的两侧有着较大的概率密度,体现了一种相对“离域性”。也可以从离子局域态理论来理解本征ZnO的绝缘性:晶体学认为ZnO中所有的价电子都被紧紧束缚在O2-上,电子将O2-的2s、2p轨道完全填满,无法移动而不导电。另外,主要由Zn的4s、4p轨道线性组合而成的导带,实际上就是反键轨道,反键轨道的电子云相对“离域”(由晶格中的所有原子所共有),轨道上没有电子,因而无法产生电导。
总之,通过如上的描述,成功地将价带这一半导体学概念具象为O2-晶格这一晶体学概念,类似地,将导带近似地具象为Zn2+晶格。这样就非常方便材料学家根据晶体学的规则来生长特定的阴离子或阳离子晶格,从而对导带或价带进行改造。
3.5.2 对施主和电子的理解
这一小节,仍然以ZnO为例,通过掺Ga过程来说明半导体能带论中施主与电子的具象化理解(见图10)。众所周知,在ZnO中掺入Ga元素所形成的替位Ga(GaZn)为浅施主能级,这一结论可以通过能带理论计算或实验结果得出。但需要注意的是,能带论并没有说明Ga的替位是如何形成的,其研究的起始点便已是Ga替位在Zn2+晶格上。在能带结构上,Ga的4s和4p轨道状态数与Zn的4s和4p轨道状态数相同,故GaZn并没有使轨道线性组合前后的状态数发生改变,即线性组合后的价带和导带价态数仍分别为8n。由于Ga原子拥有三个价电子,而Zn原子拥有两个价电子,因此当所有电子填入价带后将会富余一个价电子。这一价电子显然应该填入导带,形成自由电子,使得材料拥有导电性。仔细分析,Ga元素的掺入带来了另一个物理效应:因为原子实Ga3+比Zn2+多一个正电荷,所以缺陷结构GaZn将使得由Zn2+、O2-以及所有电子的平均场效应所形成的总体晶格中出现一个正电荷中心。正电荷中心对导带上的电子具有电荷吸引作用,形成了一种“类氢原子”的状态,“类氢原子”的基态即为GaZn的能级(见图10(f))。由于晶格中的电子与正电荷中心的作用会受到晶格中所有电子的屏蔽,因此,其作用力与H原子相比,通常会小3个数量级,即意味着GaZn形成了meV量级的浅能级。当然,也可以从另一个角度来说明浅能级的形成:原子实Ga3+的富余正电荷会在Ga原子周围的Zn2+晶格造成周期性破缺,导带的局域态也因此出现分裂,分裂出来的能级即是GaZn形成的浅施主能级。
从晶体学局域态电子理论的角度来理解这个问题,首先考虑从理论上将一个Zn2+从晶格中拿走(这只是一个思想实验,并没有考虑具体的动力学过程),为了保证材料的电中性,还必须同时带走两个电子(见图10(c))。因此,Zn2+将从其周围的4个配位O2-上夺走任意两个电子,将其中的两个O2-变成O-。然后将一个Ga原子(电中性)填入前面的VZn(见图10(e)),由于Ga原子带有三个价电子,填入时,其中两个价电子将立即被周围的两个O-所捕获,剩余的一个价电子只能留在Ga的4s轨道上(局域态)。前面提到,半导体中的导带主要由Zn的4s、4p轨道和Ga的4s、4p轨道线性组合而成,因此,上述过程实际上就相当于在导带中引入了一个电子。更为准确的描述是:由于Ga的4s、4p轨道参与Zn2+晶格(导带)的线性组合程度较低,是略低于导带的一个局域态,因此在温度极低时,富余电子将停留在Ga的4s轨道上。但温度稍高,电子就很容易被激发到Zn2+晶格组成的反键轨道(离域态)上,使材料出现导电性(见图10(h))。


图10 ZnO中施主形成过程的晶体结构及其对应的能带结构Fig.10 Crystal structure and band structure of donor formation process in ZnO
3.5.3 对受主和空穴的理解
在这一小节,将以ZnO中掺杂Li元素为例,来阐述半导体能带论中受主、空穴对应晶体学中的具象化理解(见图11)。通过能带的理论计算和实验结果,在ZnO中掺入Li元素所形成的替位Li(LiZn)为浅受主能级。但与ZnO掺Ga一样,能带论并没有说明Li元素替代的具体动力学过程,而只是通过思想实验简单地将Li填入VZn上。在能带结构上,Li的2s和2p轨道状态数与Zn的4s和4p轨道状态数相同,Li填入VZn的过程增加了Li的8个轨道状态数,相应地减少了Zn的8个轨道状态数,因此线性重组后,总的轨道状态数不变,导带和价带的状态数仍分别为8n。但总的电子数却只有(8n-1),价带上的最高态未被填满,因此LiZn能实现p型导电。对半导体学家来说,在此基础上就可以通过能带的理论计算来判断LiZn是否会形成浅能级(或受主的激发能级是否在meV量级),却很少去关注浅能级主要是由哪些轨道线性组合而成。事实上,这样的研究范式造成了无法将受主具象化的后果。深入分析就可知道,LiZn会使能带结构出现阳离子周期性的破缺。由于Li的2s、2p轨道也少量地参与了价带顶轨道的线性组合,因此LiZn缺陷结构也会对以O的2s、2p轨道组成的价带产生局域化“微调”,使得原本较为“平滑”的价带顶上分裂出一个能态稍高的局域态能级,分裂的局域态能级即为受主能级。在接近0 K时,分裂的局域态为空态,不占据电子,但温度升高将会使离域态价带顶的电子激发到分裂的局域态,从而使离域态价带顶出现未占据态,这一未占据的离域态即为半导体学家所理解的空穴(未占据态的态密度在整个晶格中处处相等,因此空穴不是一个“粒子”,而是一个“布洛赫波”)。

图11 ZnO中受主形成过程的晶体结构及其对应的能带结构Fig.11 Crystal structure and band structure of acceptor formation process in ZnO
显然,上述的理解对习惯于局域态理论的材料学家是难以接受的。接下来,将以材料学家能够接受的局域态理论来近似理解受主、空穴及其传输过程。与ZnO掺Ga类似,Li元素替位Zn的过程为:首先将一个Zn2+通过思想实验从ZnO晶格中拿走,为了保证材料的总体电中性,还必须同时带走两个电子,将Zn2+周围配位的两个O2-变成O-(见图11(c))。然后将Li原子填入VZn,它只能使两个O-中的一个变为O2-,另一个保持不变,而自身变为Li+,这一理想材料的精细化学组分完整表达式为(ZnO)1-δ(LiO)δ(见图11(e))。可以看到,Li替位Zn的过程实际上是在ZnO晶格中填入Li2O2固溶体,而不是Li2O。显然,Li2O2的氧化能力强于ZnO2,因此,Li2O2和ZnO的化学反应式应为:
(Li2O2)1/2+1/2ZnO→(Li2O)1/2+(ZnO2)1/2
(3)
当Li2O2存在于ZnO晶格中时,Li+周围的配位O-非常活跃,它可以夺取邻近与Zn配位的O2-的电子,将其自身变为O2-,对方变为O-(见图11(g))。由于晶格中与Zn配位的所有O都是等价的,因此这一过程相当于O-在晶格中“跳跃式”传播。整个ZnO晶格是由Zn2+和O2-组成的,一旦在晶格中出现了O-,意味着相应的局域晶格上出现了净正电荷,即实现了材料的p型导电。而O-能够夺取电子在晶格中无能量损失的迁移,这一过程也就等效于空穴在晶格中的迁移。

3.6 离子型晶体的导电类型取决于精细化学组分完整表达式
结合以上的认识,将进一步说明在阴离子晶格完整性前提下,精细化学组分完整表达式是如何决定载流子类型的。精细化学组分完整表达式的详细定义为:包含整个系统中所有元素的化学表达式,无论所含的元素含量有多么微小,是否能被检测到,以及是否有意掺入。因此它本质上是材料学家的语言,能够更加直观地看到材料的所有组分和载流子类型。从精细化学组分完整表达式的角度来看,p型ZnO的完整表达式为(ZnO)1-δ(LiO)δ,而n型ZnO的完整表达式是(ZnO)(Li)δ,可以看到,两者是不同的。事实上,也可以验证得到相反的结论,即精细化学组分完整表达式可以唯一确定材料的导电类型。这一理论使用了材料学家的语言来解释半导体物理学家的观念。通过这个理论,研究者将更加关注材料的完整表达式,而不是在半导体制备过程中通常无法控制的具体微观占位和空位。作为一个新颖的认识,它用重要的共同学术术语搭建起了一道桥,将能带论和局域态电子理论结合起来,并指出了能带理论中抽象概念(如空穴和受体等)的具体描述(离子和离子簇)。显然,这种认识改变了半导体制备的范式,它是普适性的,至少对于所有离子型化合物半导体来说是共同适用的。
4 ZnO的载流子策略
在理论部分已经说明,要制备一个好的半导体必须在满足阴离子晶格完整的条件下,去调控材料的精细化学组分完整表达式。如前所述,传统的半导体Si、Ge由于其天生的内禀特性,它的载流子浓度的自由调控是非常容易实现的。但在宽禁带半导体的制备中,为了满足阴离子晶格完整性需要一种特定的热力学条件(热力学条件一),而实现精细化学组成完整表达式的精确调控通常需要另外一种热力学条件(热力学条件二),这也就是离子型化合物半导体难以进行载流子自由调控的本质原因。当采用热力学条件一时,此时制备出的材料具有热稳定性,同时可以实现高迁移率,但无法调控载流子浓度;在使用热力学条件二调控材料的精细化学完整表达式时,能够获得所期望载流子浓度,但往往会破坏材料的晶格完整性,因此所制备出的离子型化合物半导体热力学稳定性较差。
鉴于上述事实,可以认为同时满足阴离子晶格完整性和精细化学组分完整表达式的精确控制,需要两个或两个以上不同的热力学过程,而不是单一热力学条件。下面根据ZnO的热力学特点,提出了如下的材料制备策略:第一步先设计一种热力学条件制备阴离子晶格完整的材料。在这一步中,精细化学组分完整表达式没有被刻意控制,因此所获得材料的载流子浓度并不是所期望的;第二步中,由于阴离子晶格已经形成,它具有忍受特定热力学环境变化的能力。这种阴离子晶格完整的动力学稳定,能够引入一个广泛调谐的热力学条件微量调控阳离子的变化,使得对精细化学组分完整表达式的精确调控变为可能。简单地说,对于宽禁带半导体,通过多步热力学过程,可以在阴离子晶格完整性的“边界条件”下实现对精细化学组分完整表达式的调控,这样才可能得到具有合适载流子浓度,同时还具备高热稳定性和高迁移率的优质半导体。这种策略揭示了材料中的载流子浓度、材料精细化学组分完整表达式以及材料制备过程中的热、动力学状态三者之间的内在联系。下面将分别以ZnO n型材料的成功制备、p型材料的尝试制备和高阻材料的初步制备为例,讲述该理论在ZnO中的具体实施措施。
4.1 热稳定n型ZnO的成功制备
通常认为,ZnO的n型导电是很容易实现的,很多条件下制备的ZnO都具有1016~1017cm-3背景自由电子浓度,这一背景自由电子浓度通常被认为是由非故意掺杂H或O空位造成的。在制备高自由电子浓度(1019~1020cm-3)的n型ZnO时,背景自由电子浓度这一因素可以被忽略,并人为引入1019~1020cm-3的施主杂质。根据固体能带理论,为了获得n型导电的ZnO,通常需要掺入组成元素周期表中的后一族元素,即ⅢA族,如掺入Al、Ga元素,其中Al元素掺杂是一类较为重要的研究课题,下面将以ZnO掺杂Al为例讲述n型ZnO的制备策略。
Al掺杂ZnO(AZO)薄膜是一种重要的透明氧化物材料,可广泛应用于太阳能电池、平板显示器件、薄膜晶体管、气敏传感器、波导器件和红外反射窗口等领域[85-90],由于其无毒、成本低、耐辐射等优点,有望替代目前商业上使用的透明导电氧化物材料,如掺锡氧化铟(ITO)和氧化铟等[88,90-93]。制备AZO薄膜的方法有很多,包括化学气相沉积(CVD)、磁控溅射(MS)、脉冲激光沉积(PLD)和分子束外延(MBE)等[88,91-94]。在实践过程中,掺入Al很容易形成高浓度重掺杂的AZO薄膜,但其载流子浓度热稳定性却很难同时实现,因此AZO薄膜虽然已经实现了部分应用,但仍未能满足高载流子浓度、高迁移率以及高热稳定性这一半导体材料的根本需求,产生这一瓶颈的原因在本团队的工作开始之前依然未得到阐明。下文将使用精细化学组成表达式的语言,在保证阴离子晶格稳定的情况下,讲述高载流子浓度、高迁移率、高热稳定性的AZO薄膜制备方法,与前期方法不同的是,在此采用了两步热力学步骤,而不是单一的热力学条件来实现理想掺杂。
理想的AZO薄膜需要同时具备低电阻率和高稳定性,低电阻率意味着高的载流子浓度和迁移率,要求掺入一定量的Al元素,同时保证晶格缺陷尽可能少;而高稳定性则要求尽量抑制热力学不稳定的缺陷,如间隙Al等的产生。换句话说,当掺入的Al全部替代Zn位点时则可以获得理想的AZO薄膜,此时理想薄膜的化学表达式为(ZnO)1-δ(AlO)δ(见图12(i))。然而,将Zn2+直接替换为Al2+在制备过程中存在着较大的动力学阻碍,其原因在于:Al2+作为一种拥有3s1电子结构的离子,是非常不稳定的。在成膜反应过程中,当环境氧含量富余时(即强氧化气氛中),所有的Al元素均以+3价形式存在,然后进行晶格沉积。为了保证阴离子晶格的完整性,就必然会出现两个Al3+的替位掺杂,并将自发产生一个Zn空位,形成半绝缘的i型半导体(见图12(e))。若在还原性气氛下(即O含量不足)进行晶格沉积,为了保证阴离子晶格完整性,部分的Al将会以0价形式存在,且Al0只能在间隙位(见图12(c))。如图12(c)可以看到,间隙铝Ali虽然仍为浅施主,但其本身的热力学稳定性很差,这就是使用常规的热力学条件,要么只能获得半绝缘的热稳定性AZO薄膜,要么获得热力学不稳定的高载流子浓度、高迁移率AZO薄膜,却无法同时获得高载流子浓度、高迁移率、高热稳定性的AZO薄膜的原因。
基于ZnO这一独有的明确热力学特征,本课题组提出了利用两步热力学过程制备AZO薄膜的策略(见图12)[95],该策略可被简单表述为:(1)首先在强氧化气氛中,制备出含有高浓度锌空位(VZn)的重掺杂AZO薄膜;(2)然后在Zn蒸汽(强还原性气氛)中退火,将锌原子填充到锌空位上。通过以上两个热力学步骤的综合处理使得薄膜结晶度、载流子浓度和迁移率可以同时提高,最终成功获得了理想的AZO薄膜。
步骤(1)中,为了保证阴离子晶格完整性,需要在富O的环境下(强氧化性气氛,氧的化学势高)制备重掺杂Al的AZO薄膜,抑制氧空位(VO)的形成,此时薄膜中的金属元素始终以最高氧化态(Al3+、Zn2+)存在。根据电中性原则,当Al3+取代阳离子Zn2+时,相应地必然会形成1/2 Al3+浓度的Zn空位,因此得到了含有高浓度VZn且重掺杂Al的ZnO薄膜。但VZn在ZnO能带中为深受主能级,故经过此热力学过程制备的AZO薄膜是高阻的。

图12 n型ZnO形成过程的晶体结构及其对应的能带结构Fig.12 Crystal structure and band structure of n-type ZnO formation process
步骤(2)是将Zn通过退火进入ZnO晶格并且扩散,最终扩散至锌空位VZn,并填入形成完整晶格,图12(g)表示Zn2+还未扩散到达VZn的情况,此时由于Zn原子已经进入晶格,它所带的两个电子将迅速被释放到导带,同时将自身变为Zn2+,在晶格中扩散(与Zn原子不同,Zn2+的半径很小,可以在晶格中迁移扩散)。图12(i)表示当Zn2+与第一步热力学过程所形成的VZn相遇时,将彼此复合,使得阳离子也实现了晶格完整性,成功制备出既具有高迁移率又具有高载流子浓度的理想AZO薄膜。原生的Zn、退火引入的Zn以及AlZn共同构成了无间隙原子的完整阳离子晶格,在薄膜制备完成后,原有晶格的Zn原子和退火引入的Zn原子事实上是无法分辨的。该过程的结构变化可以用精细化学完整表达式的化学反应式表示:
(4)
(ZnO)1-3x/2[(AlZn)2(VZn)O3(Zni)]x/2→(ZnO)1-3x/2[(AlZn)2(ZnZn)O3]x/2=(ZnO)1-x(AlO)x
(5)
通过以上两步热力学过程成功制备出了理想AZO薄膜,其迁移率为36.8 cm2·V-1·s-1,载流子浓度高达1.2×1021cm-3,电阻率为1.4×10-4Ω·cm,是目前磁控溅射法制备AZO薄膜所得最好的数据[95]。此外,该AZO薄膜在潮湿热处理(85 ℃)下表现出显著的热稳定性,其载流子浓度、迁移率,和电阻率可维持数周基本保持不变。此前文献报道的最高载流子浓度为1.5×1021cm-3,电阻率为1.9×10-4Ω·cm,迁移率为22 cm2·V-1·s-1,且热稳定性较差[88]。
4.2 p型ZnO的制备策略
如第3节所述,早期人们对ZnO的p型掺杂遵循的是Si材料制备范式:首先考虑掺入何种元素,如以ZnO为本体的p型半导体材料制备就需要掺入组成元素周期表中的前一族元素。因此,所有ZnO p型掺杂的方法可总结为以下三大类:(1)试图利用比Zn前一族的IA族中Li、Na等阳离子对Zn2+进行替换;(2)试图利用比O前一族的VA族中N、P 等阴离子对O2-进行替换;(3)试图利用共掺的金属原子来稳定受主掺杂离子的形成。通常来说,第三种方法没有半导体研究上的意义,无需进行分析。而很多条件下表明,N、P元素为阴离子掺杂,实验条件苛刻,同时,材料制备时要求较低的温度,这也不利于完整阴离子晶格的形成(在后面的4.5小节中,提出了利用MOCVD直接进行掺N的p型ZnO制备思路)。因此,这里主要以ZnO掺Li为例,根据前述的理论来分析如何制备高载流子浓度、高迁移率、高热稳定性的p型ZnO。
理论上,ZnO中的替位Li能够形成浅受主从而实现材料的p型导电,然而,Lii却是浅施主,若Lii和LiZn等当量共存,则材料仍是绝缘的。晶格中仅含有LiZn的理想p型ZnO材料精细化学组分完整表达式为(ZnO)1-δ(LiO)δ(见图13(g))。下面将分析在单一热力学条件下,这种理想的材料很难实现的原因。若首先考虑实现精细化学组分完整表达式调控的热力学条件,从p-ZnO的精细化学组分完整表达式可以看到,它本质上就是Li2O2在ZnO中的固溶体。而Li2O2的形成需要强氧化气氛,且其晶体结构与ZnO 的晶体结构有很大不同,因此在强氧化性气氛下,Li、Zn共存反应所生成的固溶体很大概率上将会导致Li2O2在ZnO晶格中团聚,使ZnO的阴离子晶格发生较大畸变。另外,Li2O2本身的热稳定性较差,高温容易导致其分解,因此材料制备过程要求在相对较低的温度下进行,但低温并不利于完整ZnO晶格的形成。综合来看,优先考虑材料精细化学组分完整表达式的调控将使得材料的晶格完整度受到限制,制备出来的材料即使为p型,也将是热力学不稳定的;相反,若首先考虑实现阴离子的晶格完整性,则通常需要较高的温度,而Li2O2的固溶体比Li2O的固溶体在高温条件下更易形成。此时,化学完整表达式为(ZnO)1-δ(LiO)δ的材料如果已经实现了阴离子晶格完整性,相应的阳离子晶格也必然是完整的,但却有富余的δ个Li原子只能填到间隙位。这就是当前在单一热力学条件下掺Li所出现的主要现象,即Li掺杂通常得到的是有着等当量的δ-LiZn和δ-Lii,而不是所期望的更多的LiZn远大于Lii。掺杂其他IA族元素情况是完全一样的,而掺杂VA族元素(例如N),在单一热力学条件下,它更倾向形成精细化学组分完整表达式为(ZnO)1-δ/2(Zn3N2)δ/2的稳定物质,这仍然是i型,在这里由于篇幅限制不再赘述。
所以,为了解决上述热力学条件的两难困境,本团队参照第4.1小节中的高迁移率AZO薄膜的制备过程,提出了一个多步热力学过程制备p型ZnO的策略(见图13)[83]。第一步是在强氧化气氛中将ZnO的块体或薄膜单晶进行退火处理。此步骤的目的是在阴离子晶格完整性的“边界条件”下,制备Zn空位(VZn),所得材料为具有深能级的p型半导体;第二步是用 Li 填充 VZn。该方法是在还原性Li或CH3Li-蒸汽中退火引入Li原子,或采用电化学方法将Li掺入ZnO晶格。为了使这一过程充分反应,必须引入过量的Li,因此富余的Li不可避免地会填入间隙位形成Lii,并且Lii的浓度会大于LiZn的浓度,故此时制备出的是有着净施主浓度的n型导电材料;第三步是将第二步中引入富余的间隙Li(Lii)赶出晶格。将上一步所得材料在真空或弱氧化性气氛中进行低温退火处理,将相对不稳定的Lii挤出晶格,同时维持LiZn的稳定,一旦晶格中的Lii以及其他背景浅施主(如H)的总浓度小于LiZn的浓度,净的浅受主能级就可以形成,从而制备出具有高迁移率和高载流子浓度稳定性的p型ZnO。

图13 p型ZnO形成过程的晶体结构及其对应的能带结构Fig.13 Crystal structure and band structure of p-type ZnO formation process
4.3 p型ZnO的实践尝试
4.3.1 针对单晶的p型尝试
显然,以目前的商用设备是很难实现上述多步骤热力学过程的。在第一步中,需要使Zn原子从已经完整的阴、阳离子晶格中溢出,产生VZn,同时需保证O晶格尽可能完整,而这样的热力学条件事实上是很难实现的。使Zn原子溢出晶格所需的热力学条件为μZn(ZnO)>μZn(环境),这一条件相对来说是容易实现的,因为Zn本身具有较高的蒸汽压(700 ℃下约为63 Pa),且在很大浓度范围内,始终满足μZn(ZnO)>μZn(环境)这一条件,所以在高温和强氧化气氛中很容易将Zn从晶格中蒸发出来形成VZn。但是制备时还必须同时保证O晶格完整这一热力学条件,即需要满足μO(环境O)>μO(ZnO)。以外部环境中的O均以O2形式存在为例,根据化学势表达式:
(6)

第二步是将受主Li元素掺入ZnO,最初尝试将金属Li源与ZnO单晶放置在同一密闭容器中进行退火处理,但由于Li过于活泼,在高温下会与大多数密闭容器(如石英)发生反应,掺杂效果不理想。因此又参考Li电池中浸Li的思路,自主设计制造了室温受主Li元素掺入ZnO晶片的电化学反应池,如图14(c)所示。该放电电池阳极为金属Li,阴极为ZnO单晶,其电化学过程为:Li+从上面的LiPF6电解质中扩散进入ZnO晶格中,电子从与ZnO接触的下面电极进来,这一过程可以用电极反应式(7)来描述:
Li++VZn+e-→LiZn
(7)
为了使反应平稳进行并同时维持阴离子晶格完整性,还在电路中引入了一个控制电流的装置。可以看到,通过电极反应所得ZnO的PL光谱中VZn信号消失了,表明该反应成功进行。
在第三步中,需要创造弱氧化性气氛来去除Lii,同时保证LiZn是稳定的。为了实现这一热力学条件,所设计的退火设备如图14(e)所示。过去曾尝试使用了O2、NO等气氛来进行退火,从实验结果上看,制备所得的p型ZnO的稳定性仍不甚理想,并且在退火过程中又会再次产生VZn的信号(见图14(f))。总体来说,目前使用ZnO单晶来实现这一过程存在一定的难度,尚未找到将Li“赶出”晶格的同时保证VZn不再产生的热力学条件,另外,一些动力学的控制因素也还未被摸索出来。
4.3.2 针对薄膜的p型尝试
本课题组尝试利用ZnO单晶,通过NO气氛退火处理,来实现材料的p型导电,但由于退火过程的热力学因素尚不明确,动力学因素相对复杂,导致在单晶材料中也并没有出现理想的实验结果。然而,上一小节中的制备方法在薄膜中却实现了较好的p型掺杂,其原因可能在于薄膜的体积较小,Lii溢出晶格的动力学过程更容易实现。最终,在掺Ga的ZnO同质外延层上成功制备出了p型ZnO薄膜,其质量表征结果如图15(b),(c)所示[83]。
针对p型ZnO薄膜的制备路线为(见图15 (a)):首先在ZnO∶Ga(重掺n型、热力学稳定度很高)的 MOCVD同质外延层上制备出具有完整晶格的i-ZnO薄膜。然后与p型ZnO单晶制备中的第一、二步骤相同,通过电化学方法掺入Li元素,制得LiZn>Lii的薄膜材料。最后,将薄膜放在与步骤三条件相同的NO气氛下进行退火,最终实现了薄膜的p型转化。由于这里制备所得的p型ZnO薄膜是同质外延层,p型和衬底外延将自动形成p-n结,这个p-n结有着良好的整流特性,开启电压在3.4 V附近,加上金属电极后所制成的每一个器件都有肉眼可见的电致光发射,这证实了该策略在制备p型ZnO上的可行性。
4.4 一个意外的结果:高阻ZnO单晶
众所周知,在ZnO单晶生长过程中总是会不可避免地掺入一定浓度的非故意掺杂H,它充当浅施主,使得原生ZnO为n型导电,其精细化学组分完整表达式为ZnHδO。然而,杂质H在ZnO单晶中十分顽固,即使是在高温退火条件下也无法完全去除,这就是前文中提及的ZnO单晶无法作为压电材料实现广泛应用的主要原因。
但在探索制备p型ZnO单晶的过程中,本课题组偶然发现了一个高阻ZnO单晶的制备方法[96]。其制备过程的第一步与p-ZnO单晶制备的第二步相同,首先利用水热法生长所得原生ZnO(载流子浓度约为1016cm-3)进行电化学掺杂,直接将Li离子引入ZnO单晶晶格中,此步骤所得ZnO单晶中的Li缺陷主要为Lii,其精细化学组分完整表达式为Zn1-σHδLiε。然后,将上一步制备所得的ZnO单晶放入填充20 atm(2.03×106Pa)氧气的密封不锈钢管炉中,在800 ℃下进行退火处理,在这一实验过程中,可以发现:把Li缺陷赶出晶格的同时,杂质H也因为某些未知的原因被同时赶出ZnO晶格(见图16, 可以看到,后者谱图中H缺陷的信号几乎消失,表明了大多数H原子被赶出了ZnO晶格),最终在ZnO晶格中形成深受体VZn,使得载流子浓度大幅下降。可以用精细化学组分完整表达式来简要表述这两个热力学过程:
ZnHδO→Zn1-σHδLiεO→Zn1-σO
(8)
其中σ、ε、δ均为小量以保证晶格的完整性。
根据前面提出的普适性载流子自由调控理论,通过电化学掺杂与强氧化气氛退火处理相结合的两步热力学过程,成功制备出电阻率约为1011Ω·cm、载流子浓度小于105cm-3的高阻ZnO。并基于此高阻ZnO单晶材料成功制备了光电导型的高能射线探测器,该探测器可以在107V/cm的强电场下工作[96]。另外,这种超低载流子浓度的ZnO单晶在压电方面的应用,如制作声表面波、压电光学、超高压场效应晶体管等,也具有良好的前景。

图14 自主研发的用于三步热力学过程的设备截面示意图,以及每一步对应的光致发光光谱[83]Fig.14 Schemes of the self-developed equipment for the three-step thermodynamic process, and the photoluminescence spectra results[83]
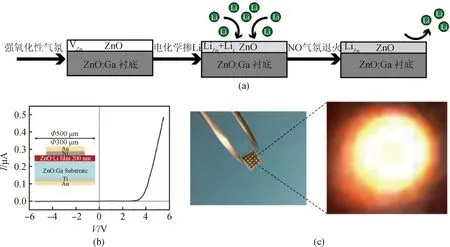
图15 多步热力学过程制备p-ZnO单晶薄膜及其质量表征结果[83]Fig.15 Schemes of multi-step thermodynamic process to fabricate p-ZnO thin films and the quality characterization results[83]

图16 1H魔角旋转核磁共振谱[69]Fig.16 1H solid-state MAS NMR spectrum[69]
4.5 p型ZnO制备的其他路径及相关设备设想
如第4.3.1小节所述,由于一些尚不明确的动力学原因,可能导致了p型ZnO单晶的制备较为困难,因而,当前的工作重心应转向p型ZnO薄膜材料的制备。需要注意的是,制备p型ZnO薄膜的路线并不一定需要遵循第4.3.1小节中所描述的步骤,由于薄膜的掺杂相对来说较为容易,在保证阴离子晶格完整的情况下,可以首先直接进行阳离子掺杂。因此在这里提出了至少两条p型掺杂的可能路径:
(1)直接制备出事先掺入Li元素的、阴离子晶格完整的ZnO薄膜,该薄膜的精细化学组分完整表达式为(ZnO)1-δ(Li2O)δ(见图17(a~c))。在这一基础上,再将材料按照第三步的要求在NO气氛下进行退火,将Lii赶出晶格,最终制备得到的p型ZnO薄膜将非常有希望直接形成p-n结。根据上述的p型ZnO制备思路,必须对现有的MOCVD设备进行改造,设备改造的目标是设计一个能够实现具有中等氧分压的腔体,进而满足p型ZnO的成膜热力学条件。初步考虑使用O2作为氧化剂,在700 ℃左右的环境下进行成膜,该制备环境有利于材料形成完整的阴离子晶格。与此同时,因为Li2O的蒸汽压很低,所以必须加大Li元素的掺入,即加大有机Li源的量,使得尽可能多的Li留在晶格中。同时为了使留驻Li和晶格完整性形成良好的匹配,很可能需要使用锯齿型的温度控制条件(见图17(a)),即在相对较低的温度下沉积一层含高Li组分的ZnO薄膜,薄膜的厚度约为3~10 nm,此时薄膜的晶格完整度较低,然后在相对较高的温度下,将低Li组分的ZnO薄膜沉积在高Li组分ZnO薄膜上,前者薄膜的厚度与后者相同,但其晶格完整度更高。沉积得到如图18(b)所示的薄膜,再将此薄膜在NO气氛中进行退火,去除晶格中的间隙Lii,最终得到掺Li的p型ZnO薄膜(见图17(c))。
(2)通过N元素掺杂来实现p型ZnO的制备[97](见图17(d)~(f))。利用类似的薄膜交替沉积结构,首先考虑使用NO作为氧化源,制备出掺入一定浓度N的ZnO薄膜,此时要求环境的温度较低,制备所得薄膜的晶格质量较高,薄膜的厚度大约为3~10 nm。然后使用O2为氧化源,在此薄膜上沉积未掺杂的纯ZnO薄膜,此时材料制备的环境温度相对较高,最终得到的沉积层晶格质量较高,厚度大约为1 nm。之后不断地反复交替沉积得到如图17(e)所示的薄膜,再将此薄膜在O2气氛中进行退火,去除ZnO晶格中的间隙Zni,最终得到掺N的p型ZnO薄膜(见图17(f))。
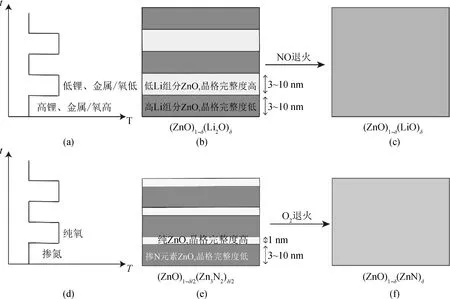
图17 p型ZnO制备的两条路径设想Fig.17 Two paths for p-type ZnO fabrication
5 ZnO材料在其他应用领域的潜力发现和进展简介
在介绍部分中提到,ZnO材料由于其自身的结构和物理特性,最初分别在压电、非线性光学及半导体应用领域被预测具有良好的应用前景。然而,在对ZnO继续深入探索的过程中,人们却遇到了一些意外的、非本征特性上的瓶颈(如本应为压电材料的ZnO出现导电性、较难获得稳定的p型ZnO等),阻碍了它的实用化进展。尽管如此,也正是因为ZnO材料在上述领域中长远的应用潜力,促使人们去发展高质量、大尺寸单晶生长技术。之后,在可获得大尺寸单晶的基础上,人们又意外地发现了一些原本没有受到重视的其他应用方向,由于技术条件的成熟,这些方向反而可能领先于原本看好的领域取得实际应用进展。在材料发展历史上,这样的例子是很多的。目前对于ZnO来说,除了AZO,IGZO等薄膜的应用外,ZnO块体单晶有两个领域的应用是值得重视的:第一个是掺杂ZnO单晶在亚纳秒级超快闪烁体中的应用;第二个是低载流子浓度、高迁移率的ZnO单晶在中红外透明导电窗口中的应用。下面将针对ZnO单晶在上述两方面的应用及领域内待解决的关键科学问题进行简要阐述。
5.1 ZnO 超快闪烁体
经过一个多世纪的发展,高能射线成像已经在工业生产、医疗健康、安全保卫等领域中取得了广泛应用[98],其基本原理是利用闪烁体将高能射线转换为可见光[99-100],然后采用常规的光电探测方法将可见光转化为电信号并读出。人们现已开发出了许多能在医疗健康等前述领域使用的闪烁体材料,一些典型的闪烁体材料(包括各类闪烁晶体和荧光粉等[101-105])已列于表3。然而,这些闪烁体材料却不能完全满足应用于高端科研领域的高能射线成像,例如,对高能物理过程的观测。高能物理过程,尤其是人工高能物理过程(如受控核聚变)的反应时间通常非常短,其伴生的各种高能射线辐射脉冲图像时间也极短。通常来说,为了深入理解高能物理过程的反应机制和历程,需要至少实现亚纳秒级的高能射线成像,进而才能够通过科学研究来优化反应的工程条件,使得反应朝着期望的方向发展。
当前能满足高能物理过程成像需求的闪烁体材料是很少的。影响闪烁体材料的主要性能参数为发光效率、发光衰减时间和发射光谱等,而高能射线成像领域最为关注的性能参数为材料的发光衰减时间。如果材料的发光衰减时间太慢,上一时刻未衰减完的残留图像将更加显著地叠加在当前时刻的成像结果上,使得图像的时间分辨率下降,无法对超快过程进行监控。目前常用闪烁体材料的发光性能参数已列于表3,可以看到:常用的闪烁体材料NaI∶Tl 与 LSO 的衰减时间较长,分别为60 ns和40 ns;荧光粉材料Y2SiO5∶Ce的衰减时间更长,达到120 ns,不能满足高速成像的要求;有机闪烁体虽然具有较快的衰减时间,但其原子序数低,导致其对X射线的截获率低,不适用于X射线相关应用;目前希望较大的闪烁体材料是BaF2,虽然其发光快,可以满足应用需求,且原子序数高,但它的发光包含两个部分:快成分为短波长、占比低;慢成分为长波长、占比高,不利于超快过程的动态诊断。

表3 常用闪烁材料的发光性能[106-110]Table 3 Luminescent properties of some typical scintillator materials[106-110]
事实上,ZnO材料的超快发光特性很早就被发现了。1966年,美国西屋研究实验室的Lehmann在Ga和In掺杂的ZnO粉末中首次发现了ZnO亚纳秒时间尺度的超快发光特性[111]。在这之后,ZnO作为荧光粉被用于阴极射线显像中[112]。1968年,美国麻省理工学院核科学实验室的Luckey认为ZnO粉末的快响应将有望用于辐射探测领域[113],然而,当时的生长工艺还不成熟,ZnO大多以粉末的形式存在[114],因此未能引起高能射线探测领域的普遍关注,使得超快成像的应用需求也一直未能得到满足。2004年以来,在面向ZnO材料半导体研究项目的支撑下,本团队经过近15年的努力,在水热法生长高质量、大尺寸纯ZnO单晶方面取得了重大突破,现已可获得尺寸接近4英寸(10.16 cm)的ZnO单晶。在此基础上,又迅速开展了ZnO∶Ga(GZO)单晶的水热生长工作,同样也获得了大尺寸的GZO单晶。最初,本课题组并没有考虑将GZO单晶应用于高能射线探测领域,而是将它用作p-n结的n型衬底。但在晶体研制过程中,偶然注意到了GZO单晶作为闪烁体材料具有很大的应用潜力,且很有可能成为ZnO晶体真正进入生产应用的首例。于是,本团队与西安交大的欧阳晓平院士团队合作,将制备得到的大尺寸ZnO单晶在自主搭建的单光子计数的时间分辨光谱测试系统中,直接测得了α粒子激发下ZnO∶Ga 单晶具有亚纳秒级超快辐射衰减时间[113]。在最近的报道中,欧阳晓平院士的团队将本团队提供的块体ZnO∶Ga单晶作为闪烁屏,构建了高时间分辨率的瞬态辐射成像系统,测试结果表明,系统具有纳秒级别的时间分辨率,闪烁体-记录系统的空间分辨率达到了1.12 lp/mm[115]。
想要更好地将ZnO∶Ga单晶作为超快闪烁屏应用于超快高能辐射动态成像,除进一步提高晶体尺寸,还需要克服一些关键的问题:(1)ZnO闪烁发光效率低。目前,发光效率低是约束ZnO在辐射探测领域应用的主要问题。常用的闪烁体例如 NaI∶Tl、CsI∶Tl、LaBr3、LSO 等的光产额普遍在30 000 photons·MeV-1以上,然而,在高能射线激发下,ZnO的光产额仅为NaI∶TI的1%。但通过对材料的本征改性,如在ZnO中掺入稀土发光离子、Ga-In共掺等,可以提高其光产额。另外,在ZnO单晶表面制备单色光增透膜或者光子晶体等手段也有望提高材料的光产额;(2)ZnO还存在着自吸收的问题。ZnO的吸收边与自身带边区域的发光重叠,这将导致本来就不强的发光被自身强烈吸收,使得发光进一步减弱。因此,如果能提升ZnO的发光效率,可以预见其在辐射探测领域的应用将得到极大的拓展。(3)ZnO闪烁发光不均匀。应用于辐射成像领域的闪烁屏不仅需要大尺寸的样品,还需要样品表面不同位置的发光无明显差异。目前块体ZnO∶Ga单晶生长工艺并不稳定,晶体中缺陷的存在与分布将对ZnO∶Ga的发光均匀性造成很大的影响,且ZnO∶Ga的发光与缺陷的关系、发光与温度的关系均尚未明确,这无疑也对ZnO∶Ga在超快动态成像应用方面提出了挑战。(4)由于ZnO快响应弱发光的闪烁特性,一般的检测系统还无法很好地检测到ZnO的辐射闪烁发光,因此,围绕ZnO闪烁体的高时间分辨瞬态成像应用系统的搭建也需要进一步探索。
总体来说,要想将ZnO应用于实际的超快辐射探测和成像领域中,首先,要在科学上进一步探究清楚ZnO超快闪烁背后的物理机制,从科学的角度指导ZnO闪烁特性的提高,并找到进一步提高材料发光效率的方法;其次,在材料生长制备上,更大尺寸、高质量、均匀的块体单晶获取问题仍然需要进一步攻坚;再者,在技术层面,围绕ZnO闪烁体的闪烁屏的制备及成像应用系统的搭建也有待进一步探索。
5.2 ZnO中波红外透明导电窗口
众所周知,大部分物体发出的黑体辐射主频位于中红外8~12 μm波段,因此对这一波段的红外探测有着最为广泛的用途。一般而言,对红外波段进行探测的器件需要配备有相应的红外窗口或透镜以对其自身进行物理保护或成像。目前来说,配备在红外探测器上的透镜主要用ZnS等不导电的绝缘材料来制作。然而很多时候,红外探测器需要在复杂的电磁环境下工作,而用ZnS等绝缘材料制成的透镜无法有效地抵挡电磁波的穿过,导致红外探测器在这些环境下工作时,易出现虚警或假信号,在电磁环境更恶劣时,甚至会将“娇贵”的红外探测器摧毁。因此,如果能将红外探测器自身用金属包裹,而透镜部分选用能穿过中红外光并具备高导电能力的材料,将有望大大提高探测器对中红外波段探测的稳定性及在复杂电磁环境下的实用性。
目前为止,能够既透明又导电的材料主要是ITO(In2O3∶Sn)、AZO(ZnO∶Al)、FTO(SnO2∶F)等薄膜。这些薄膜的厚度较薄,一般呈多晶或无定形态,其高导电性的实现必须通过重掺杂使得载流子浓度达到金属般的简并量级(≥1020cm-3)。然而,对于这类高度掺杂的简并半导体材料,它们的载流子浓度很高,自由载流子形成高度简并的“气体”,红外透明范围会受自由载流子的等离子振荡(即等离子激元)显著影响,当低于等离子振荡频率的光电磁波入射时,高度简并的自由载流子气将沿着与入射磁场相反的方向相干振荡,从而屏蔽入射光电磁波,使得此类薄膜的中红外透明能力显著下降,红外透明窗口范围因而大大受限[116-118]。相对于重掺杂的另一种极限情况,非掺杂的本征半导体中透明的限制来自于本征的极性晶格振动,即受到声子极化激元效应的显著限制,此时可以归结为极性晶格振动与光相互问题[119]。
一直以来,虽然人们对中红外透明导电窗口的需求是非常明确与迫切的,但是并没有考虑通过ZnO材料来实现这一应用。这是因为在传统水热法的热力学条件下,生长所得ZnO单晶的背景载流子浓度仅有1014cm-3,同时迁移率也较低(约40~80 cm2·V-1·s-1),总电阻率可达300 Ω·cm,对复杂电磁环境下的电磁波阻挡能力不足。因此,能够将ZnO材料应用于中波红外透明窗口领域的前提条件是,找到一种在适度提高背景载流子浓度的同时,还能进一步提高迁移率接近理论极限(300 cm2·V-1·s-1)的材料新生长方法。通过热力学基础研究,本团队找到了一种新型水热矿化剂,这种矿化剂可以使得金属杂质离子在溶液或界面处的化学势远低于晶体内部的化学势,同时也可能造成背景掺杂元素H在溶液或界面处形成较低的化学势,再加上水热法近热力学平衡态的生长有利于维持阴离子晶格的稳定性,因此可以获得载流子浓度仅为1016cm-3,但迁移率却接近300 cm2·V-1·s-1的ZnO单晶材料。这一材料在8 μm左右的红外光波段仍具有很高的透过率,且在0.4~8 μm相当宽的光谱范围内保持高透过性(见图18)[80],这正好满足了该领域应用的核心指标,开创了ZnO在特定中红外波段透明导电窗口的用途。
低载流子浓度、高迁移率的块体ZnO单晶能够实现上述应用的另一个核心原因是:ZnO单晶中杂质元素H造成的背景载流子浓度(1016cm-3)是极其稳定的,甚至在700 ℃以上的退火条件下处理24 h也不会发生变化。在最近的报道中,本课题组通过ZnO单晶的核磁共振谱和红外光谱的共同解析,对材料中低背景载流子浓度的产生开展了初步科学研究[69],研究发现,三个H+可以共同挤占1个VZn从而使热力学稳定地存在于ZnO晶格中。如前所述,VZn-3H+的H缺陷结构并没有对ZnO的阴离子晶格造成破坏,因此能够保持材料的高迁移率,此时材料的精细化学组分完整表达式为ZnHδO,而这正是材料n型导电与背景载流子浓度的起源。
为了进一步对ZnO单晶中低载流子浓度与红外光透明背后的科学原理进行讨论,对载流子浓度为1015~1018cm-3的ZnO单晶(可以用不同的热力学条件获得)进行测试,得到的结果如图19所示。可以看到,在载流子浓度居中的时候,透明的限制与自由载流子的光吸收有关[120-124]。通过对ZnO的红外吸收与载流子浓度的关系进行初步的经验性的拟合分析,发现在不同的载流子浓度下,ZnO对应的自由载流子吸收机制不同[80]:载流子浓度为1018cm-3量级时,电离杂质将参与到电子的光吸收跃迁过程中;1017cm-3量级时,光学声子参与;1015~1016cm-3量级时,声学声子参与,此时光吸收程度不剧烈,透明窗口范围显著得以拓宽(见图19)。
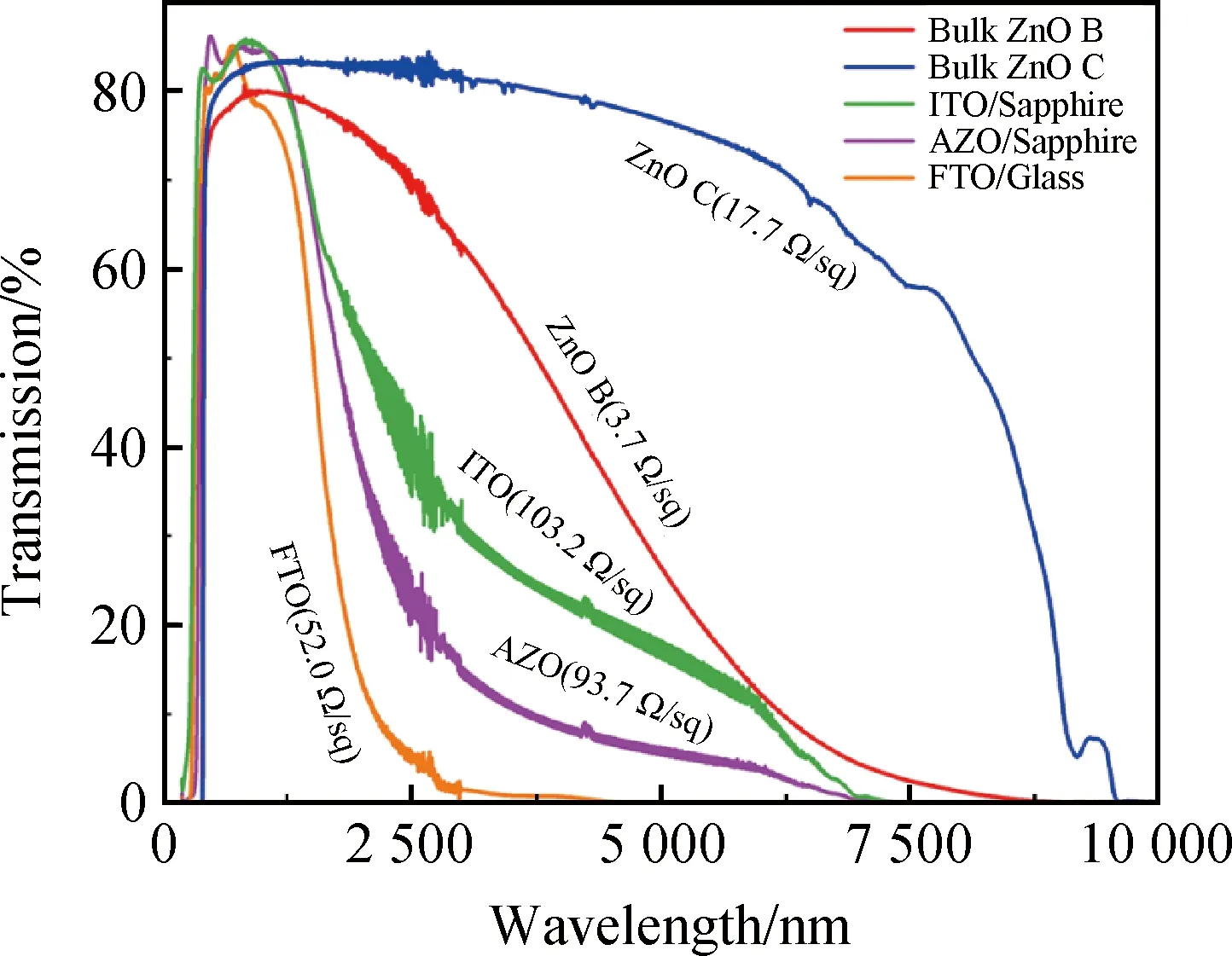
图18 重掺杂的高度简并透明导电氧化物薄膜(TCOFs)和低载流子浓度块体氧化锌单晶在红外区域的透明导电性能[80]Fig.18 Transparent and conductive properties of heavily doped degenerate TCOFs and low-carrier-concentration bulk ZnO in the infrared region[80]
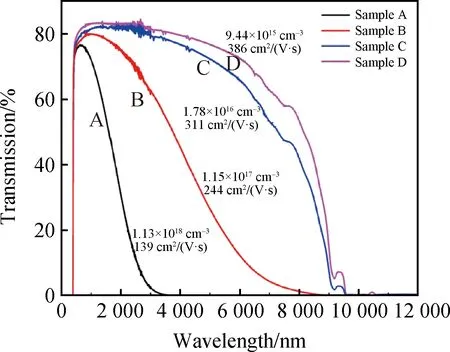
图19 不同载流子浓度的4块ZnO单晶样品的透明导电性能[80]Fig.19 Transmission spectra of the four ZnO single crystals[80]
尽管原生的ZnO表现出优异的中红外透明导电性能,但要使其作为透明导电窗口真正应用于中红外光电器件领域还需要进一步攻克一些问题:(1)水热法更大尺寸原生块体ZnO单晶的获取。(2)在更大尺寸的单晶获取的基础上,需对其生长环境中涉及的流场、温场及浓度场与载流子浓度的关系进一步研究,在这个研究基础之上,才可以获得均匀透明的大尺寸ZnO单晶材料以满足应用需求。
6 结语与展望
总体来说,ZnO材料的发展是曲折的,它在压电、非线性光学和半导体等领域都存在一定的应用潜力,但却都因为一些材料微观结构导致的瓶颈问题限制了它的实际应用。例如,在压电领域,原本被认为是绝缘体的ZnO出现了意外的导电性;在非线性光学领域,ZnO的折射率差很小,难以获得好的相位匹配;在半导体领域,难以获得高载流子浓度、高迁移率、高热稳定性的p型ZnO。因此,若能成功解决上述领域内的瓶颈问题,就很可能实现ZnO的真正应用。在本文中,一个离子型化合物半导体自由载流子调控的普适性理论被提出,并采用多步骤热力学过程,成功制备了高阻ZnO单晶和p型ZnO薄膜,为ZnO在压电和半导体领域的应用带来了新的曙光,但如缺陷形成物理机制等基础科学问题,仍有待进一步研究。在深入探索过程中,还发现了ZnO在其他应用领域(如超快闪烁体和中红外透明导电窗口)的发展潜力,而这些领域很可能先于上述领域取得实际应用进展。另外,不论是对半导体,还是超快闪烁体等应用领域,要实现ZnO的真正应用都需要单晶生长技术作为支撑。对此,本课题组设计了新型水热生长设备,如旋转釜、对流釜,以期突破传统水热釜的理论极限,获得更大尺寸、更高质量的ZnO单晶。

