硅基密封气密性及结构强度研究
吉 勇,高娜燕,燕英强,明雪飞,陈 波,丁荣峥
(中国电子科技集团公司第58研究所,江苏 无锡 214035)
硅基密封气密性及结构强度研究
吉 勇,高娜燕,燕英强,明雪飞,陈 波,丁荣峥
(中国电子科技集团公司第58研究所,江苏 无锡 214035)
探讨了硅基气密性封装的可行性,将电镀镍-金镀层的柯伐盖板、密封区金属化的硅基板用金锡焊料片通过熔封形成密封。硅是一种脆性材料,在硅基气密性密封结构中,需要研究气密性封装腔体大小对结构强度的影响(规律),以及可承受的压力。试验结果表明,腔体小于11 mm×27 mm时(腔体高度不限),350 μm厚度的硅基板可直接与柯伐盖板密封,密封结构中的硅基板不会碎裂且可承受至少0.1 MPa的压力。
硅基封装;气密性;结构强度
1 前言
气密性封装中金属封装和陶瓷封装凭借其优异的可靠性得到了广泛的应用,但随着电子工业及航空和航天工业的迅速发展,现阶段用户对于电子器件的多功能、高性能、系统化等方面的要求越来越高,同时也要求整个封装模块轻、薄、小。金属封装和陶瓷封装的封装外壳决定了整个封装体的重量无法做到很轻,并且受到外壳制作工艺的限制(如节距、布线层厚度),在进行多层布线后,其体积必然会变大,就更无法满足薄、小的需求。
硅是一种价格低廉的半导体封装材料,用硅做气密性封装外壳,以目前较成熟的半导体制程技术来看,布线层厚度能稳定控制在22 nm甚至更薄,那么即使在进行多层布线后其厚度也不会有巨大的变化,且其焊盘的节距可以控制得比金属、陶瓷封装中的节距小很多。由此不难看出,硅基气密性封装相较于金属封装和陶瓷封装,在控制封装模块轻、薄、小上的优势非常明显,再结合圆片级封装工艺的优点,大批量制造时的成本优势也很明显。
气密性密封时常使用锡焊或钎焊。锡焊通常采用Sn-Pb、In-Ag和Bi-Sn等钎料进行密封,锡焊稍次于共晶金锡合金钎焊,因为其强度约为Au80Sn20强度的1/2,并且金属间化合物的形成更容易失效,而且在大多数情况下封接时必须采用助焊剂[2],而金锡焊料有优良的机械性能,同时具有独特的润湿性和抗氧化性,可以实现无助焊剂封焊,消除了助焊剂的污染[3]。
本文研究了一种新型硅基气密性密封结构,结合硅、金锡焊料的优异特点,将表面带有镍-金镀层的盖板和表面金属化的硅基板以及金锡焊料片通过熔融形成密封。因为硅是一种脆性材料,在硅基气密性密封结构中,其结构强度在施加一定压力的情况下能支撑的空腔体积是未知的,需要对其进行研究分析。
2 试验设计
试验需要研究硅基气密性密封结构的机械结构强度、气密性以及可靠性,考虑到硅基气密性密封结构的内部需要贴装IC芯片以及硅基板,将密封腔体划分为2个部分,硅基板气密性密封结构参照图1和图5 。

图1 气密性硅基板平面布局图
用Ansys Mechanical仿真软件建立了如图2所示的模型,模型中各材料参数由工具书及公开文献获得。

图2 仿真模型建立
利用有限元的计算方法模拟对整个结构施加了0.2 MPa和0.3 MPa的压力,并据此进行了模拟计算,其仿真结果如图3、4所示。

图3 施加0.2 MPa压力仿真结果

图4 施加0.3 MPa压力仿真结果
仿真结果显示,在施加0.2 MPa压力时,腔体边缘硅基板所产生的应力最大值达到了84.6 MPa;而在施加0.3 MPa压力时,腔体边缘硅基板所产生的最大应力值则达到了122 MPa,在如此大的应力之下,硅基板将会在最大应力处发生碎裂。
为增加硅基板的结构强度,我们考虑有选择地在部分硅基气密性结构内的硅基板上贴装一定厚度的单晶硅片,密封完成后进行加压测试,检测其气密性及结构强度。
试验中硅基板为单晶硅,盖板为柯伐合金(因盖板制作工艺限制,将盖板拆分为盖板和焊框,再用焊料焊接在一起);硅基板上溅射金属层,盖板和焊框表面镀镍-金;硅基板、焊框、盖板间放置预成型焊料片Au80Sn20,经过合金烧结后形成气密性密封,具体封装结构参见图5。

图5 硅基气密性密封结构剖面图
根据试验设计,使用JM7000导电银胶将芯片贴装到硅基板上。
3 试样制备
本文中密封采用了氮气气氛保护下的烧结工艺,并设计了特殊夹具防止烧结过程中硅基板、柯伐焊框、柯伐盖板以及两层预成型金锡焊料片之间发生偏移,另外还可根据实际需求调整为真空密封。硅和柯伐合金盖板之间并不能直接焊接,因此需要对硅基板、焊框和盖板的表面进行金属化处理,各零件表面金属化层设置情况如表1。

表1 零件表面金属化设置表
本次试验共组装样品4只,2只未贴装裸硅片的样品编号1号、2号,2只贴装裸硅片的样品编号3号、4号。设计的柯伐盖板厚度0.4 mm,柯伐焊框厚度1 mm,硅基板、IC芯片厚度均为0.35 mm。
硅片贴装到硅基板上的工艺条件为:200 ℃恒温5 min,300 ℃恒温60 min,无气氛保护;硅基气密性结构密封工艺条件为:260 ℃恒温2 min,340 ℃恒温2 min,自然降温,氮气气氛保护。
密封后外观检查:首先对样品表面进行目检,观察样品硅基板面是否有裂纹,然后使用X射线仪检查烧结面孔隙情况。
检漏过程:根据GJB548B-2005方法1014.4密封的要求,样品全部放入125 ℃氟油进行粗检漏;无肉眼可见气泡的继续进行细检,其中1号、4号样品加压0.2 MPa,保持2 h;2号、3号样品加压0.3 MPa,保持2 h后;加压完成后对样品表面再次进行目检,观察样品硅基板面是否有裂纹;最后将硅基板面无明显裂纹的样品浸入125 ℃氟油,浸泡过程中观察是否有气泡。
4 试验结果
密封完成后的4只样品中,1号大腔体有裂纹,小腔体无裂纹,2号、3号、4号样品无裂纹,样品密封完成后硅基板面和金属盖板面的实际情况见图6。使用X射线仪检查样品合金烧结面,均未发现贯通性气孔,但存在不同程度孔隙,设计烧结面宽度2 mm,最大孔隙宽度1.138 mm,孔隙集中在整个焊接面的一侧位置,焊接面孔隙情况见图6。
检漏后,1号样品通过处理后仅保留小腔体硅基板,通过0.2 MPa加压测试及氟油浸泡,小腔体处硅基板保持正常,且浸泡过程未发现气泡;2号样品加压0.3 MPa后,大、小腔体硅基板均发现裂纹;3号样品加压0.3 MPa后,大腔体硅基板发现裂纹,小腔体处无裂纹但浸入氟油后临近大腔体焊环处硅基板崩裂;4号样品加压0.2 MPa后,大腔体出现裂纹,小腔体无裂纹,浸入氟油中时,大腔体炸开,将临近小腔体焊环处的硅基板崩裂。检测后样品情况见图7。
5 分析与结论
硅基气密性结构完成密封后无贯通性气孔,但存在的孔隙宽度与设计的焊接宽度仍有较大差异,需要对密封的工艺条件进行优化。
分别施加0.2 MPa、0.3 MPa压力后,硅基气密性密封结构的大腔体都发生了不同程度的碎裂,与模拟计算结果最大应力位置基本一致,而样品中小腔体的完整,表明空腔面积小于11 mm×27 mm时,350 μm厚度的硅基板可以承受至少0.1 MPa的压力。
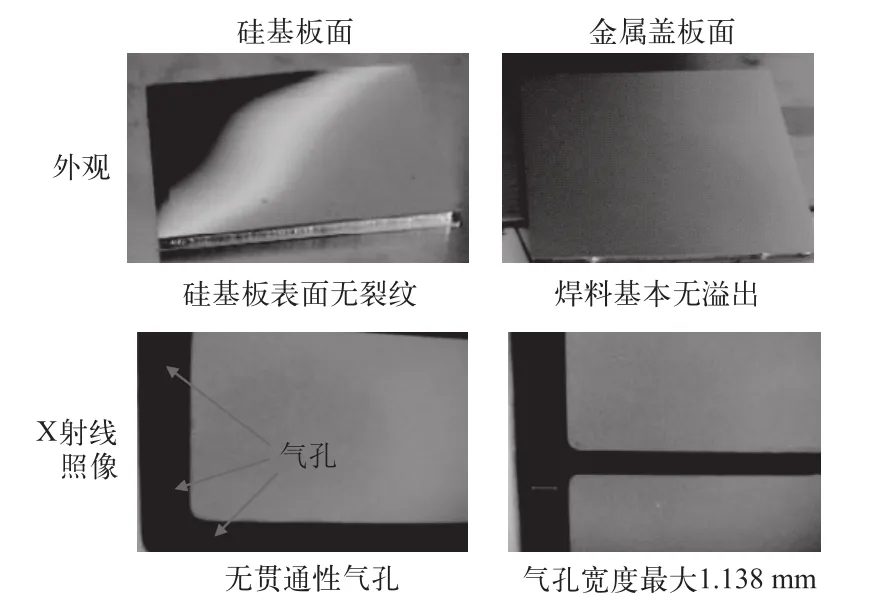
图6 样品密封后情况

图7 检测后样品情况
值得一提的是:该结构在经历近320 ℃的降温后仍能保持一定的气密性,柯伐合金盖板和硅基板的气密性密封结构具备一定的可行性,后续如能对内部结构设计进行优化,能给硅基板实现气密性密封带来新思路。
[1] 解启林,朱启政. MCM组件盒体与盖板气密封装倒置钎焊工艺方法[J]. 电子工艺技术,2007,28(4):211-213.
[2] 徐骏,胡强,林刚,等. Sn-Bi系列低温无铅焊料及其发展趋势[J]. 电子工艺技术,2009,30(1):1-4.
[3] 姚立华,吴礼群. 采用金锡合金的气密性封装工艺研究[J]. 电子工艺技术,2010,31(5):267-270.
Study of the Silicon Hermetic Package Tightness and Structural Strength
JI Yong, GAO Nayan,YAN Yingqiang, MING Xuefei, CHEN Bo, DING Rongzheng
(China Electronics Technology Group Corporation No.58Research Institute,Wuxi214035,China)
To research the feasibility of one novel silicon hermetic package, welding the cover with nickel and gold surface, silicon substrate surface metalized and Au80Sn20 solder pieces. Need to research the effect of cavity area changes that influence the silicon package’s structure strength and the pressure that package could support, for silicon is a brittleness material. The results showed, when the section acreage of cavity less than 11 mm×27 mm, 350 μm thickness silicon substrate can weld with kovar cover directly, and the package can support at least 0.1 MPa pressure while the silicon substrate with no crack.
silicon package; hermetic; structural strength
TN305.94
A
1681-1070(2014)08-0015-03
2014-05-08

