重离子引起SiC MOSFET栅氧化物潜在损伤研究
于庆奎,曹 爽,张琛睿,孙 毅,梅 博,王乾元,王 贺,魏志超,张洪伟,张 腾,柏 松
(1.中国空间技术研究院 宇航物资保障事业部,北京 100029;2.国家级抗辐照应用技术创新中心,北京 100029;3.南京电子器件研究所 宽禁带半导体电力电子器件国家重点实验室,江苏 南京 211111)
新一代航天器对高压功率器件提出了迫切应用需求,如新一代深空探测航天器的电推进系统需要使用千伏以上的高压功率器件[1],空间太阳能电站能量转换和传输系统需要使用高压功率器件[2]。与硅器件相比,SiC器件的工作电压达到千伏以上,且具有工作温度高和功耗低的优点,在新一代航天器中有非常好的应用前景[1,3]。航天器工作在空间辐射环境中,必须开展抗辐射研究。国内外对SiC MOSFET开展了较多的单粒子效应研究,发现重离子辐照下,其辐射效应与入射离子线性能量传输(LET)和偏置电压有关,会出现的辐射效应有:1) 氧化层潜在损伤;2) 离子引起漏电流(SELC);3) 单粒子烧毁(SEB)[4-6]。国际上对SiC MOSFET的SELC和SEB研究较多,文献[6-7]研究指出当入射离子LET大于10 MeV·cm2/mg,在约100 V漏源偏置电压下,离子在SiC MOSFET栅氧化物中引入潜在损伤,在约200 V或更高偏置电压下,发生SELC退化,SELC退化不可恢复;在400 V左右偏置电压下,离子会引起SEB。文献[4,8-11]研究认为离子引起的SiC MOSFET内部永久损伤导致漏电流和击穿电压下降与入射离子LET和漏源偏置电压有关。Yan等[12]研究了离子入射角度对漏电流的影响,指出垂直入射产生的漏电流损伤最严重。Peng等[13]研究认为SELC与离子累积注量有关。关于SEB,Abbate等[14]研究认为2个离子重复轰击同一个位置,损伤积累,最终发生SEB。Liu等[15]通过仿真研究了增加高掺杂P+区有减缓SiC MOSFET发生SEB的作用。文献[16-17]试验和仿真研究了SiC MOSFET的SELC和SEB机理。Robert等[18]根据SELC与入射离子注量和偏压关系的研究结果,指出应根据应用条件,包括偏置电压、轨道高度及寿命周期等,评估SELC的影响。总结国内外研究进展可得出,SiC MOSFET单粒子效应和硅器件不同:SiC MOSFET在低电压(如10%左右额定击穿电压)就会发生离子引起的SELC,并在栅氧化物中引入潜在损伤,离子引入的栅氧化物潜在损伤在栅应力作用下会退化,引起单粒子栅穿(SEGR),造成器件功能失效,在40%~50%额定击穿电压下会发生SEB,由于在栅氧化物中引起潜在损伤所需要的偏置电压比引起SEB的更低,可得出SiC MOSFET栅氧化物单粒子效应最敏感;在硅器件中,离子引起的SELC影响不显著,几乎在接近额定击穿电压或SEB阈值电压时,才会发生离子引起的SELC[7]。因此,需要开展SiC MOSFET单粒子效应研究,特别是离子引起氧化物潜在损伤的规律。在SiC MOSFET单粒子效应评估中,应适当评估离子引起氧化物潜在损伤的影响,否则会导致错误的评估结果,影响其可靠应用。对于硅MOSFET,为了评估氧化物潜在损伤,现有的SEB和SEGR试验方法标准规定了辐照后栅应力(PIGS)测试要求,要求PIGS测试栅应力时间不少于1 s[19]。对于SiC MOSFET,为了准确评估离子引起的氧化物潜在损伤对器件可靠性的影响,需要掌握SiC MOSFET栅氧化物损伤的变化规律和影响因素,包括与偏置电压、入射离子LET和注量等之间的关系以及PIGS测试栅应力时间要求等。
本文以4个生产厂的1 200 V SiC MOSFET为对象,在加速器上进行重离子辐照,辐照中器件加电并实时原位测量电特性,辐照后进行PIGS测试,研究离子引起的栅损伤随偏置电压、入射离子LET和注量以及PIGS测试栅应力时间等的变化规律,为制定SiC MOSFET单粒子试验方法提供支持,同时为器件加固和空间应用提供参考。
1 试验样品和条件
试验样品为平面结构1 200 V SiC MOSFET,来自4个生产厂(以下分别称为A、B、C和R),均为非加固器件。辐照前,被试器件开帽,露出芯片,并编号测试,电性能均合格。重离子试验在中国原子能科学研究院HI-13串列静电加速器、中国科学院近代物理研究所回旋加速器HIRFL和哈尔滨工业大学300 MeV质子重离子加速器SESRI上进行。采用碳(C)、锗(Ge)、钽(Ta)、铋(Bi)和铀(U)离子,离子在芯片表面的LET在0.26~118 MeV·cm2/mg之间,在硅中射程均大于30 μm。
在离子辐照过程中,被试器件漏源间加50~600 V静态偏置电压,栅源短接,实时测量漏极和栅极漏电流IDS、IGS,根据产品手册规定,当IDS超过100 μA时,判为器件失效;当IGS超过100 nA,判为栅氧化层失效。辐照后,进行PIGS测试。PIGS测试方法为施加栅电压VGS,从0 V开始,以1 V为台阶增加到20 V,漏源电压为0 V,测试IGS。除另有注明,栅应力施加时间为1 s。重离子辐照试验和PIGS测试均在室温下进行。
2 试验结果和讨论
2.1 SiC MOSFET重离子辐照试验结果
取样品在加速器SESRI上进行辐照试验。SESRI以12 s时间周期输出离子,在12 s时间周期内,3 s时间有离子输出,9 s时间无离子输出。用重离子Bi,其能量为1 200 MeV,芯片表面LET为97.5 MeV·cm2/mg,注量率为5×103cm-2·s-1,分别在50 V和100 V漏源偏置电压(栅源短接)下对4个生产厂的器件进行注量为105cm-2的辐照。当加速器输出离子时,漏极和栅极检测到瞬态电流,测试结果列于表1。典型被试器件瞬态电流测试结果示于图1,瞬态电流出现的时间间隔约为12 s,与加速器输出离子的周期相吻合,因此,判断是离子引起的瞬态电流(SETC)。由图1可看出,A-176被试器件在100 V漏源偏置电压下,无离子辐照时栅极漏电流IGS小于10 pA;有离子辐照时,离子引起的栅极瞬态电流最大值约为500 pA,离子束停止,栅极漏电流基本恢复到初始值。无离子辐照时,漏极漏电流IDS小于100 pA;有离子辐照时,离子引起的漏极瞬态电流最大幅度约为25 nA,离子束停止,漏极漏电流基本恢复到初始值。

a——栅极;b——漏极图1 被试器件A-176在100 V偏置电压下Bi离子辐照中的瞬态电流Fig.1 Transient current measured for device A-176 during Bi ion irradiation at 100 V bias voltage

a——栅极;b——漏极图2 被试器件A-178在200 V偏置电压下Bi离子辐照中的漏电流Fig.2 Leakage current measured for device A-178 during Bi ion irradiation at 200 V bias voltage
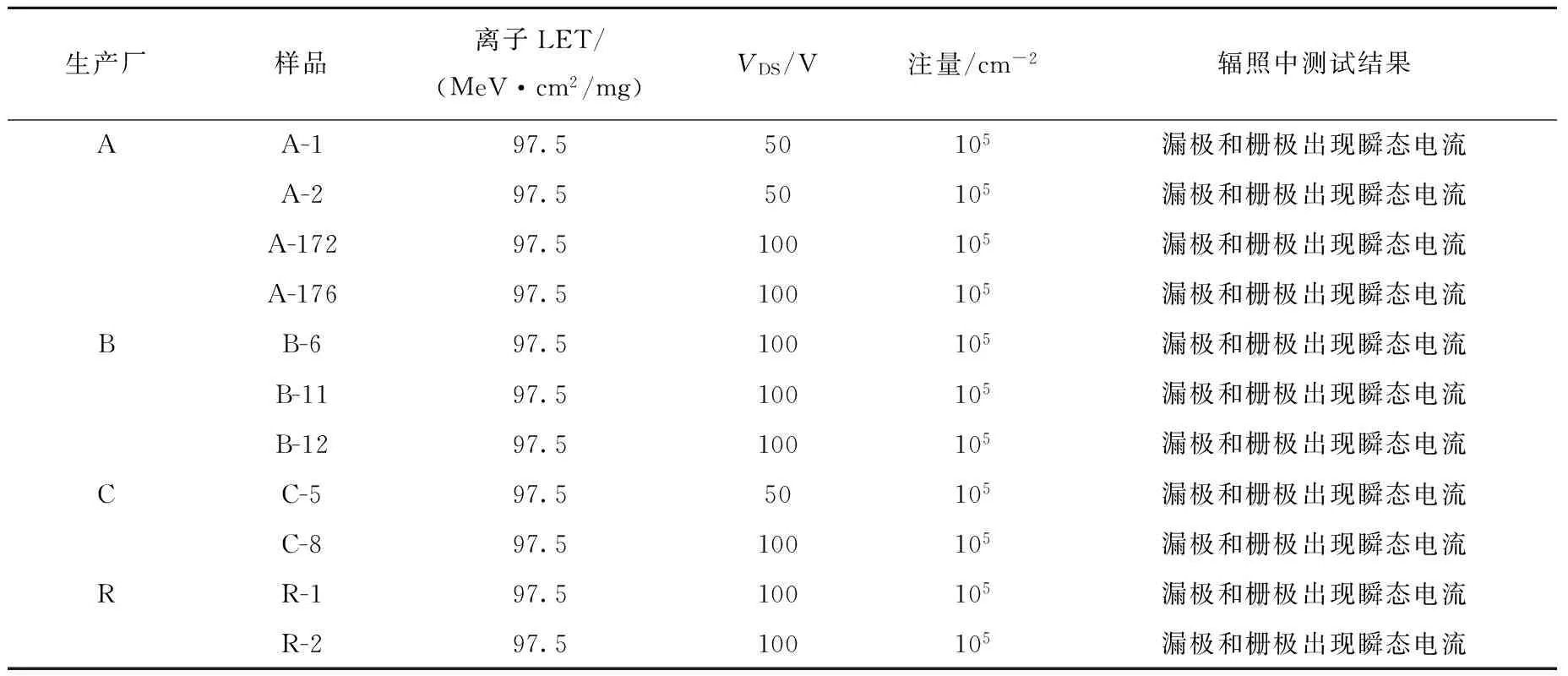
表1 1 200 V SiC MOSFET在50 V和100 V偏置电压下重离子辐照测试结果Table 1 Test result of 1 200 V SiC MOSFET under heavy ion irradiation at 50 V and 100 V bias voltages
重新取样品在加速器SESRI上用Bi离子、200 V漏源偏置电压下辐照注量为105cm-2,测量到和入射离子相对应的漏极和栅极漏电流阶跃增加。典型被试器件漏电流阶跃增加的测试结果示于图2,可看出,漏电流约每12 s阶跃增加,加速器离子输出周期为12 s,因此判断器件漏电流阶跃增加是入射离子引起的SELC。试验结果表明,漏电流随入射离子累积增加,离子束流停止,漏电流未恢复,说明离子在器件栅氧化层引入不可恢复的损伤,导致漏电流不恢复。
取样品分别在HI-13串列静电加速器、加速器HIRFL和SESRI上用C、Ge、Ta、Bi和U离子辐照。离子LET为0.26~118 MeV·cm2/mg,漏源偏置电压为200~600 V。测试结果列于表2,当离子LET为0.26 MeV·cm2/mg时,被试器件未发生SEB或SEGR;当离子LET为37~118 MeV·cm2/mg时,被试器件发生SEB。试验结果验证了离子LET和偏置电压增加,重离子会引起SiC MOSFET发生SEB。另外,200 V偏置电压辐照离子注量106cm-2发生SEB,在相同LET下辐照离子注量105cm-2未发生SEB,表明离子引起的损伤与注量有关。
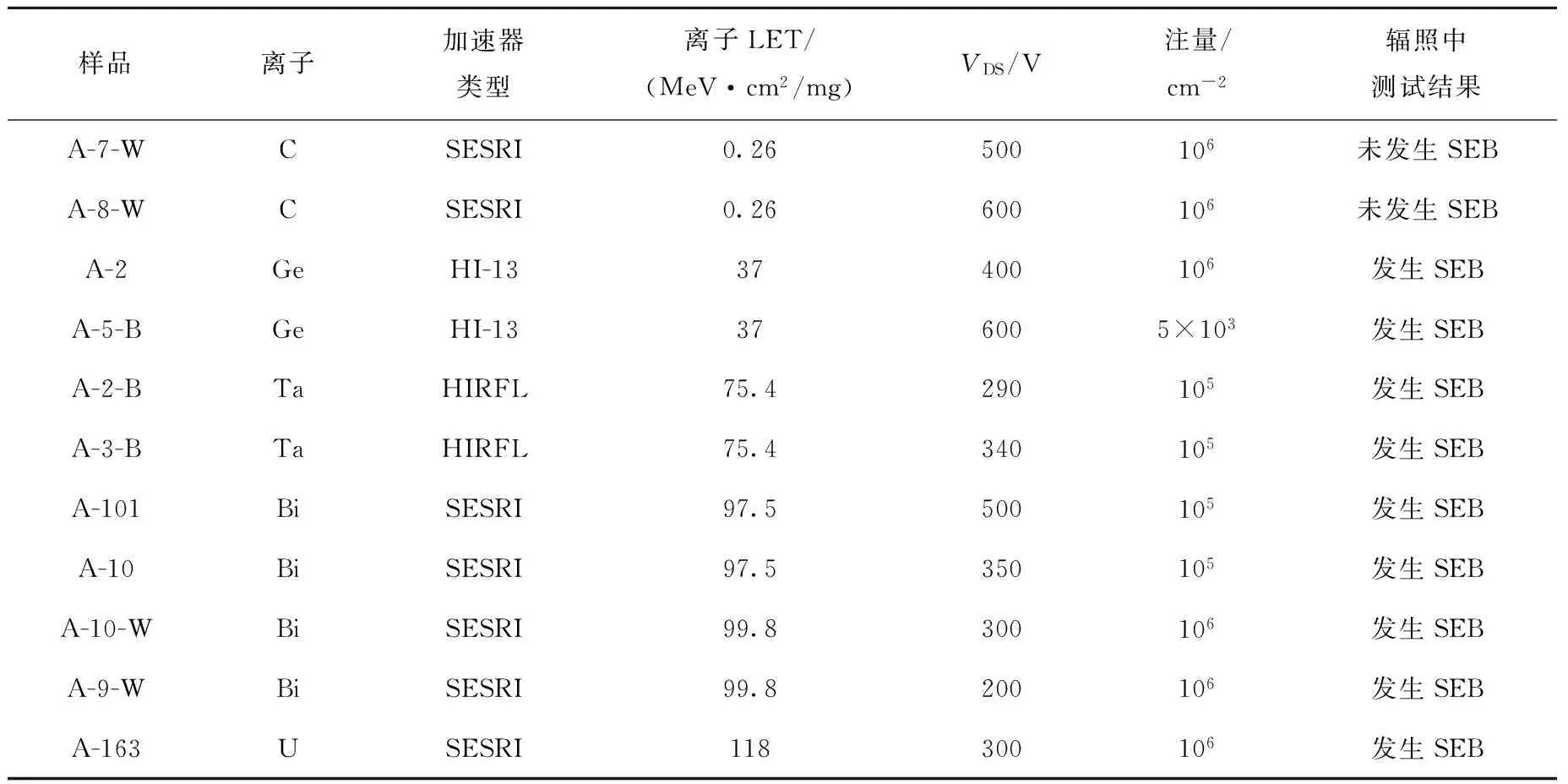
表2 1 200 V SiC MOSFET重离子引起SEB试验结果Table 2 Test result of SiC MOSFET SEB induced by heavy ions
2.2 PIGS测试结果
对重离子辐照过程中出现SETC的被试器件进行PIGS测试。经过50 V漏源偏置电压下辐照注量105cm-2的器件,PIGS测试过程中栅漏电流无明显变化,PIGS测试通过;经过100 V漏源偏置电压下辐照注量105cm-2的器件,PIGS测试中栅漏电流均超过100 nA,栅失效。测试结果列于表3。典型器件PIGS测试过程中栅漏电流随栅电压的变化示于图3。根据试验结果推断,经过100 V偏置电压辐照注量105cm-2的被试器件,离子在栅氧化层中产生潜在损伤,在PIGS测试过程中,潜在损伤在栅电压应力作用下,进一步退化,导致栅失效。根据50 V偏置电压辐照的被试器件PIGS测试未出现栅失效、100 V偏置电压辐照的被试器件PIGS测试出现栅失效,得出氧化物潜在损伤程度与辐照偏置电压有关。

图3 被试器件A-172 PIGS测试中栅漏电流随栅电压的变化Fig.3 Change of gate leakage current with gate bias voltage during PIGS test for device A-172

表3 出现SETC的器件PIGS测试结果Table 3 PIGS test result for device with SETC
为了进一步验证氧化物潜在损伤程度与辐照偏置电压有关,取样品A-143用Bi离子辐照,离子LET为97.5 MeV·cm2/mg,辐照后进行PIGS测试,测试结果列于表4。在50 V漏源偏置电压辐照后,PIGS测试栅电流无明显变化;在75 V漏源偏置电压辐照后,PIGS测试栅电流IGS增加1个数量级,在100 V漏源偏置电压辐照后,PIGS测试栅失效,试验验证了氧化物潜在损伤随辐照偏置电压增大而严重。

表4 SiC MOSFET在不同偏置电压后PIGS测试结果Table 4 PIGS test result for SiC MOSFET irradiated at various bias voltages
2.3 氧化物潜在损伤与离子注量的关系
为了获得栅氧化物潜在损伤与离子注量的关系,进行了不同注量辐照试验。取样品在加速器SESRI上用Bi离子辐照,离子能量为1 200 MeV,芯片表面LET为97.5 MeV·cm2/mg,注量率为5×103cm-2·s-1。在50 V漏源偏置电压下分别辐照累积注量105、106和107cm-2,在每个累积注量下分别进行PIGS测试。测试结果列于表5,辐照累积注量为105cm-2时,PIGS测试栅漏电流无明显变化;辐照累积注量为106cm-2时,PIGS测试栅漏电流增加,IGS从pA量级增加到50 nA;辐照累积注量为107cm-2时,PIGS测试栅漏电流IGS增大到1 μA,栅失效。测试结果表明离子引起的氧化物潜在损伤与离子注量有关,呈现累积效应。

表5 1 200 V SiC MOSFET辐照不同累积注量后PIGS测试结果Table 5 PIGS test result for SiC MOSFET irradiated at various fluences
2.4 氧化物潜在损伤与离子LET的关系
为了验证氧化物潜在损伤受离子LET的影响,取样品采用C、Ge、Bi离子辐照,辐照中实时检测被试器件IGS和IDS。辐照中未检测到SEB和SEGR发生。辐照后PIGS测试结果列于表6。试验结果表明,入射离子LET增加,PIGS测试不通过的可能性增加,验证了氧化物潜在损伤的严重程度与入射离子LET具有正相关性。

表6 不同离子LET辐照PIGS的测试结果Table 6 PIGS test result with various LETs
2.5 栅应力时间的影响
取样品在HI-3串列静电加速器上用Ge离子辐照,芯片表面LET为37 MeV·cm2/mg,离子在硅中射程为30 μm,注量率为2×103cm-2·s-1,辐照注量为105cm-2,漏源偏置电压为200~300 V。辐照后进行PIGS测试,测试结果列于表7。由表7可看出:在200 V偏置电压下辐照的器件,触发栅失效需要的栅应力时间超过300 s;在250 V偏置电压下辐照的器件,触发栅失效需要的栅应力时间为12~69 s;在300 V偏置电压下辐照的器件,触发栅失效需要的栅应力时间为1 s。分析认为,高偏置电压下离子引起的潜在损伤严重,需要的栅应力时间短,因此,得出PIGS测试需要的栅应力时间与栅氧化物潜在损伤的严重程度有关。

表7 栅应力时间的测试结果Table 7 Test result of gate stress time
2.6 分析讨论
由试验结果可知,在50 V漏源偏置电压下,随注量增加离子可引起潜在损伤,在栅应力作用下,会引起栅失效,低于文献[6-7]给出的100 V潜在损伤阈值;PIGS测试栅应力时间与损伤程度有关,会超过300 s。因此,应关注离子引起潜在损伤对器件可靠性的影响,进行宇航用SiC MOSFET辐射效应评估时,需要针对性地进行潜在损伤影响的评估。Abbate等[14]指出重离子引起SiC MOSFET失效机理是两个以上离子重复轰击同一位置,损伤累加,导致失效。该机理可以解释重离子引起的SiC MOSFET辐照损伤具有累积效应,但在辐照注量105~107cm-2情况下,两个离子重复击中同一位置的概率很小,几乎可忽略不计,该机理不太有说服力。分析认为可能的失效机理是电荷累积引起的,高能离子在SiC中电离出电子-空穴对,在SiC中形成一个瞬时导电路径。图4为高能离子在SiC MOSFET中电离出导电通路示意图,在漏源加偏置电压、栅源短接的情况下,该导电路径的产生使得部分漏源偏置电压也加在漏栅之间,电离产生的电子-空穴对在电场作用下分别朝相反的方向漂移,其中,空穴在栅氧化层下面聚集。在50~100 V漏源偏置电压下辐照,入射离子电离的空穴在栅氧化层下面聚集,增加了栅氧化层上的电压,导致氧化层内电场增加,当电场增加到足够大时,会在栅氧化层引入潜在损伤。栅极不同位置入射离子产生的电荷对氧化层内电场增加具有叠加作用,因此,多个重离子引起的损伤具有累积效应。在200 V偏置电压下辐照,电荷在栅氧化层两边聚集的足够多,导致氧化层内电场过高,在栅氧化层引入不可恢复的损伤。

图4 高能离子在SiC MOSFET中电离出导电通路示意图Fig.4 Current path induced by heavy ions in SiC MOSFET
为进一步解释重离子造成SiC MOSFET栅极损伤的现象,使用Sentaurus TCAD仿真工具建立二维仿真模型。仿真器件结构和关键参数列于表8。
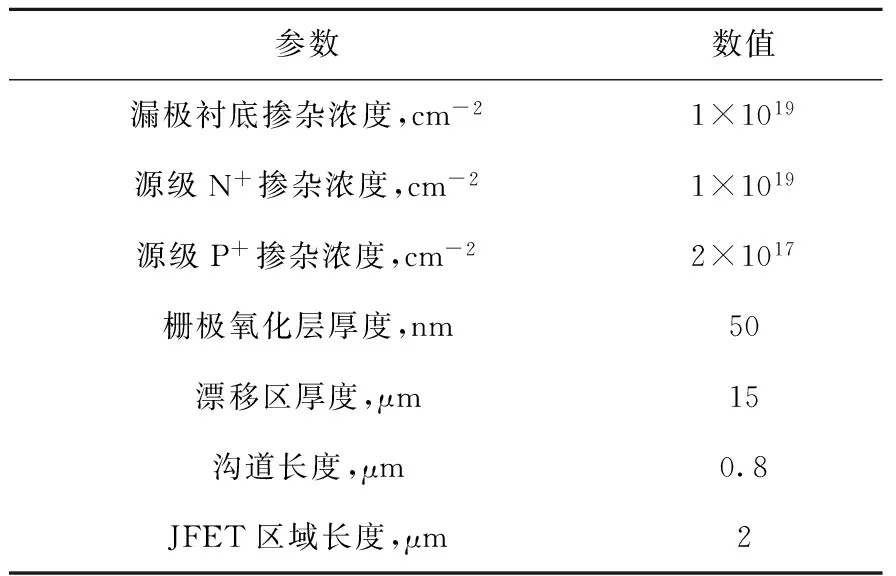
表8 TCAD仿真的主要参数Table 8 Main parameter for TCAD simulation
根据SiC MOSFET的材料特性,在仿真的物理模型中考虑不完全电离模型、禁带变窄模型;对于载流子的输运,考虑漂移扩散模型;对于载流子的产生复合考虑SRH模型、俄歇复合和电场驱动的雪崩击穿模型;对于载流子迁移率,考虑掺杂模型、高电场饱和模型。由于需要仿真重离子入射,所以同时考虑了重离子模型,重离子对栅极损伤的最坏情况是离子从关态器件的栅极中心表面垂直入射,本文采用这一入射方式,重离子的主要参数列于表9。
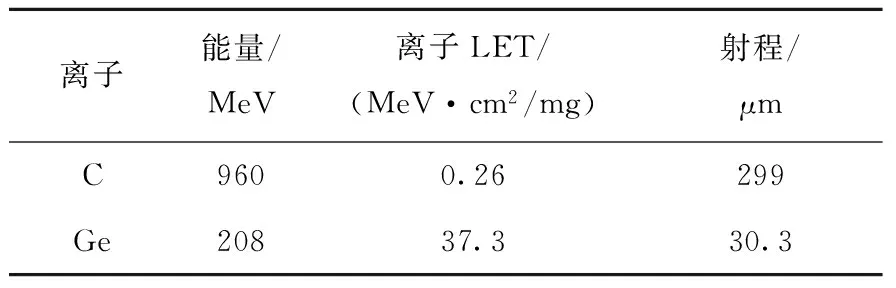
表9 仿真使用的离子参数Table 9 Main characteristic of heavy ions used in simulation
重离子射程保证可以穿过整个器件的漂移区(>15 μm),高斯分布径迹半径为0.05 μm,重离子的LET设置为0.25 pC/cm和0.02 pC/cm(相当于SiC材料的37 MeV·cm2/mg和0.3 MeV·cm2/mg)。为研究重离子入射对栅极损伤的影响,仿真重离子入射时的瞬时电场分布情况,图5为VDS=100 V、Ge离子入射时间t=4 ps时,SiC MOSFET栅极区域的电场分布。重离子入射后,在轨迹周围形成大量电子-空穴对的等离子柱,在强电场作用下,电子和空穴没有复合,而是被电场驱动产生瞬时电流,漏极电压将会耦合到栅极上,导致栅极电场增大,这是重离子引起栅极损伤的重要原因。
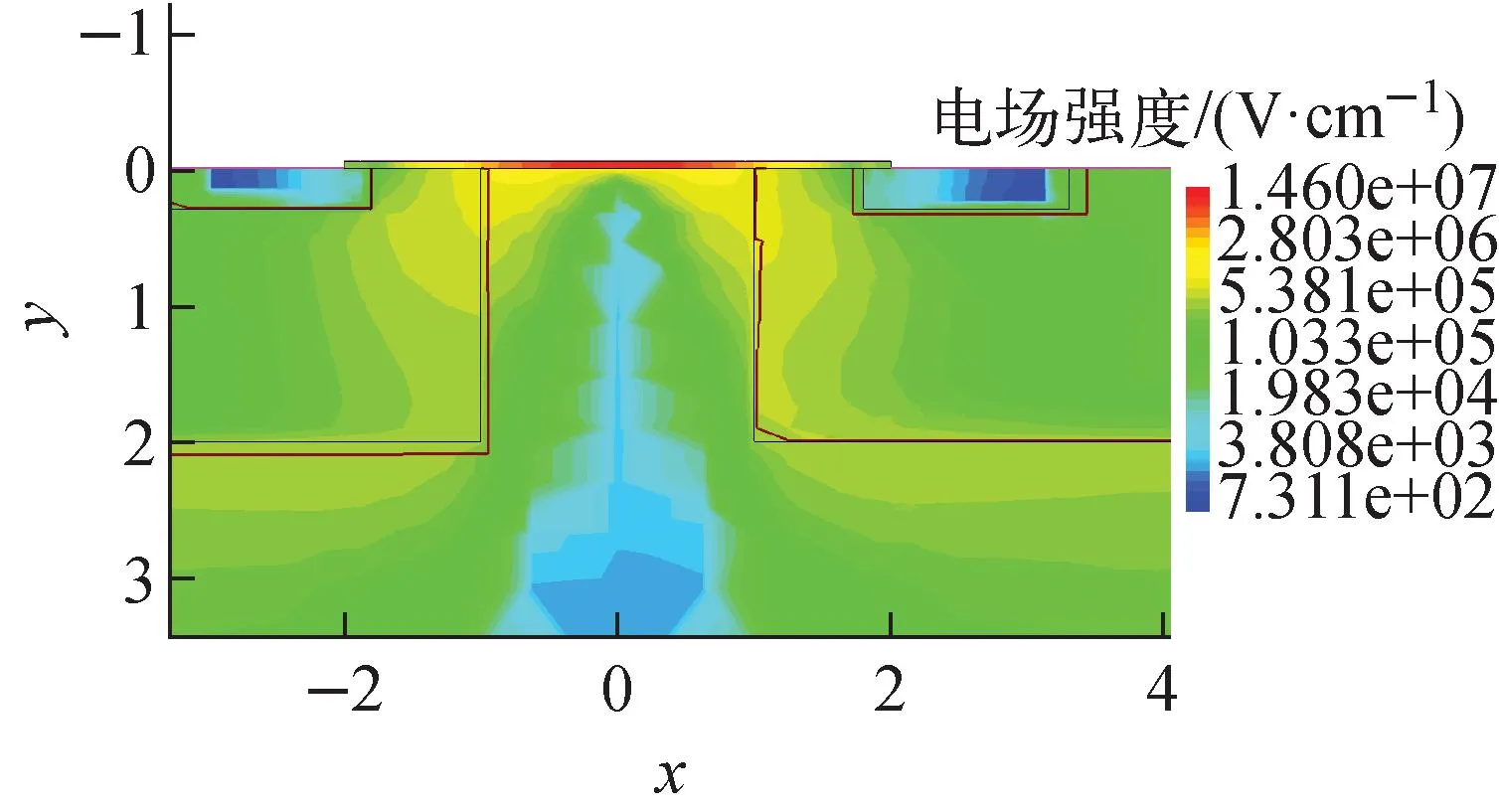
图5 VDS=100 V、Ge离子入射时间t=4 ps时SiC MOSFET栅极区域的电场分布Fig.5 Electric field distribution in gate region of SiC MOSFET with VDS=100 V and Ge ion incidence time t=4 ps
仿真VDS=100 V和VDS=200 V偏置电压时Ge离子入射SiC MOSFET的栅极电场随时间的变化情况,结果如图6所示。同一离子入射时,不同偏置电压下栅极电场EOX随时间变化的趋势相同,t=4 ps时栅极电场达到最高值,VDS=200 V时EOX_MAX=27.8 MV/cm,VDS=100 V时EOX_MAX= 14.7 MV/cm。栅极峰值电场随偏置电压升高,会导致更严重损伤产生。

图6 VDS=100 V和VDS=200 V偏置电压时Ge离子入射过程中SiC MOSFET栅极电场变化Fig.6 Change of gate electric field of SiC MOSFET during Ge ion incidence at VDS=100 V and VDS=200 V
研究入射离子LET对SiC MOSFET栅极损伤的影响,仿真VDS=100 V时Ge和C离子入射对栅极电场的影响,结果如图7所示。在同一偏置电压下,LET低的C离子导致的峰值电场EOX_MAX=6.7 MV/cm,LET高的Ge离子导致的峰值电场EOX_MAX=14.7 MV/cm,更高的LET会导致更严重的栅极损伤。

图7 C离子(LET =0.26 MeV·cm2/mg)和Ge离子(LET =37 MeV·cm2/mg)入射过程中SiC MOSFET栅极电场的变化Fig.7 Change of gate electric field of SiC MOSFET during incidence of C ions (LET=0.26 MeV·cm2/mg) and Ge ions (LET=37 MeV·cm2/mg)
3 结论
用重离子辐照1 200 V SiC MOSFET,在50~100 V偏置电压下离子引起栅氧化物潜在损伤,潜在损伤会引起栅失效;在200 V偏置电压下离子引起的不可恢复的损伤;在200~600 V偏置电压下离子引起SEB。试验和仿真分析确认离子入射引起栅氧化物潜在损伤与偏置电压、入射离子LET和注量等呈正相关。试验结果表明栅单粒子效应最敏感,在约5%额定击穿电压下会发生离子引入的氧化物潜在损伤引起器件失效。在SiC MOSFET加固和空间应用中,需要评估离子引起的氧化物潜在损伤的影响,应根据轨道和任务周期确定试验用离子注量和偏置电压,并确定适合的PIGS测试栅应力时间。
感谢中国原子能科学研究院郭刚研究员团队、中国科学院近代物理研究所刘杰研究员团队和哈尔滨工业大学刘超铭副教授、王天琦副研究员、刘剑利研究员及其团队在重离子试验过程中给予的帮助。

