位移损伤效应对AlGaN/GaN HEMT器件的影响
陈柏炜,孙常皓,马 腾,宋宏甲,王金斌,彭 超,张战刚,雷志锋,梁朝辉,*,钟向丽,*
(1.湘潭大学 材料科学与工程学院,湖南 湘潭 411105;2.工业和信息化部电子第五研究所 电子元器件可靠性物理及其应用技术重点实验室,广东 广州 511370)
第3代半导体氮化镓(GaN)由于其优异的物理特性与电特性,使GaN高电子迁移率晶体管(HEMT)被广泛应用于射频放大器和功率开关等领域;由于其良好的抗辐照特性,被应用于航空航天、深空探测、核相关等领域。GaN材料的禁带宽度为Si的3倍(3.39 eV),临界击穿电场大于Si的10倍,具有极化效应引起的高二维电子气(2DEG)浓度(1013~1014cm-2)、高二维电子气迁移率(1 800~2 200 cm2·V-1·s-1)[1-2]、高温高压稳定性、高剂量辐照稳定性等优点。在航空航天环境中,质子、中子、重离子、电子、γ射线等粒子会对半导体器件造成复杂的影响[3],如质子和中子、重离子的辐射会导致位移损伤效应[4-7],电子束的辐照会造成栅极漏电流降低[8]等。在深空探测[9]、核设施等环境中,辐射的注量会比航空航天环境高得多。进行更高注量级辐照实验,有助于剖析辐照损伤的物理机制,对器件制造的工艺优化提供参考。
高能带电粒子产生电离损伤时,所损失的能量可在靶材料中产生电子-空穴对。质子辐照会导致器件产生位移损伤效应和电离效应,其中引起的电离效应可忽略不记[10]。由于中子本身不带电,在入射时不会产生电离损伤。尽管次级粒子碰撞会产生少量电子-空穴对,但数量级较质子辐照产生的电子-空穴对低得多,故中子是进一步验证AlGaN/GaN HEMT器件位移损伤效应的理想粒子。2020年,Yue等[11]对AlGaN/GaN HEMT进行总注量高达5×1014cm-2的3 MeV质子辐照,主要的退化机制被认为是沟道中带负电的陷阱密度增加,耗尽更多电子并降低二维电子气的载流子迁移率;2021年,Wang等[12]在中子辐照后器件反向漏电流降低并保持AlGaN/GaN器件的其他电学性能不变,但未探究中子辐照对器件的作用机理;2022年,Sun等[13]进行了3 MeV质子辐照实验,总注量4×1014cm-2,用Poole-Frenkel模型解释质子辐照退化机理,认为质子辐照后,器件的缺陷能级变深,电子没有足够的能量从陷阱态激发到导带,因此反向栅极漏电流减小;2023年,Cui等[14]发现中子辐照会影响2DEG迁移率和HEMT的表面状态。仅单一研究质子或中子造成的损伤,对于同样可造成位移损伤的粒子——质子、中子,进行横向对比尚有待研究。
在此,基于此前质子辐照位移损伤效应的研究[11,13],进行中子辐照实验,探究器件退化的异同。本文进行3 MeV质子和14 MeV中子实验,并对辐照前后的器件进行输出曲线、转移曲线、栅极漏电流-电压(Igs-Vgs)曲线测试与深能级瞬态谱(DLTS)测试。
1 样品和实验装置
本文选择的实验器件为Al0.18Ga0.82N/GaN HEMTs,采用金属有机化学气相沉积(MOCVD)方法在碳化硅(SiC)衬底上制备。图1为器件结构示意图,器件栅长210 μm,栅宽160 μm,源漏间距3.5 μm,Al0.18Ga0.82N势垒层18 nm,AlN间隔层1 nm,GaN缓冲层2 μm。
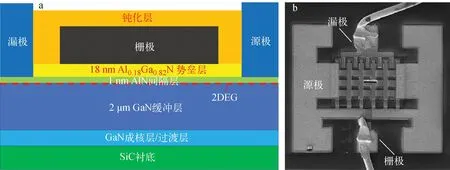
a——器件横截面示意图;b——Al0.18Ga0.82N/GaN HEMTs的微观表面形貌图1 器件结构示意图Fig.1 Schematic diagram of device structure
质子辐照实验在北京大学重离子物理研究所EN-18质子加速器中进行,质子能量为3 MeV,注量率为1.48×1010cm-2·s-1,束斑面积为2 cm×2 cm的区域,并将两个器件分别累计注量达到4×1014cm-2和1×1015cm-2。整个质子辐照期间质子处于正入射。未对器件施加偏置电压,器件所有管脚全部悬空。中子辐照实验在合肥物质科学研究院中子源进行,中子能量为14 MeV,注量率为2×107cm-2·s-1,将两个器件累计注量分别达到1.2×1012cm-2和2×1013cm-2。整个辐照期间未对器件施加偏置电压,器件所有管脚全部悬空,实验在室温下进行。
使用SRIM软件模拟质子非电离能量沉积率的等效结果,3 MeV质子的非电离能量沉积率为5.156×10-2MeV·cm2·g-1,结果与文献[15]相符;14 MeV中子的非电离能量沉积率约为2×10-3MeV·cm2·g-1[15],与ATSM标准[16]相符。
2 辐照测试结果
采用KEYSIGHT B1500A半导体器件分析仪测试了质子、中子辐照前后器件的电学特性。通过饱和输出曲线、阈值电压、峰值跨导和栅极漏电流分析,发现辐照后AlGaN/GaN HEMTs器件电学特性退化。
2.1 质子辐照
图2为两种器件质子辐照前后的输出曲线、转移曲线和Igs-Vgs曲线的对比。在较高的质子累积注量下,器件的饱和漏极电流(Ids)退化更为严重。当质子注量累积到4×1014cm-2时,饱和漏极电流下降16%;当质子累积到1×1015cm-2时,饱和漏极电流下降37%。在转移曲线测试中,漏极电压为2 V,栅极电压从-5 V扫描到1 V,如图2c、d所示阈值电压正向漂移分别为0.29 V(正向漂移13%)和0.54 V(正向漂移24%)。在Igs-Vgs的测试中,栅极电压从-20 V扫描到2 V。从图2e~f可看出,当质子注量累积到4×1014cm-2时,反向栅极漏电流变化不大,总体趋势略有增加。然而,当质子注量累积到1×1015cm-2时,反向栅极漏电流下降1个数量级。两个器件的正向栅极漏电流几乎无变化,这意味着器件的肖特基势垒高度无变化[16-18]。

图2 质子辐照前后的输出曲线(a、b)、转移曲线(c、d)和Igs-Vgs曲线(e、f)Fig.2 Output curves (a, b), transfer curves (c, d) and Igs-Vgs curves (e, f) before and after proton irradiation
2.2 中子辐照
14 MeV中子辐照前后的输出曲线、转移曲线和Igs-Vgs曲线如图3所示。中子注量累积到1.2×1012cm-2时,器件的饱和漏极电流轻微下降;当中子注量累积到2×1013cm-2时开始有退化趋势,并且阈值电压正向漂移更明显。反向栅极漏电流在1.2×1012cm-2时几乎无变化,在2×1013cm-2时开始增加,而两个器件的正向栅极漏电流几乎无变化。

图3 中子辐照前后的输出曲线(a、b)、转移曲线(c、d)和Igs-Vgs曲线(e、f)Fig.3 Output curves (a, b), transfer curves (c, d) and Igs-Vgs curves (e, f) before and after neutron irradiation
3 分析与讨论
GaN基器件被进行过大量研究。质子辐照GaN基器件时,一般会出现饱和漏极电流降低、阈值电压正向漂移、峰值跨导降低等现象,但反向栅极漏电流显著降低[11,19-20]。本文使用DLTS分析了反向栅极漏电流的机理。DLTS方法是表征深层杂质能级最灵敏的电测量技术,它基于空间电荷区域的杂质电荷通过电压脉冲显示出的电容变化来表征。使用DLTS方法测量由该过程引起的电容变化,可确定深层杂质的浓度分布、活化能和横截面。
图4为质子辐照前后的DLTS测试图。在DLTS测试图(图4a)中,纵坐标d为电容,通常认为显示的是缺陷浓度(NT)的相对值[13],而NT与缺陷表面态的浓度(NS)有关,故测试时应保持辐照前后NS一致;横坐标为温度,代表着该缺陷在此温度下被激发,通过DLTS测试图峰值电容的位置拟合出阿伦尼乌斯(Arrhenius)曲线,通过拟合得出缺陷能级。

图4 质子辐照前后DLTS测试结果以及阿伦尼乌斯图Fig.4 DLTS spectra test results and Arrhenius plots determined before and after proton irradiation
器件受到质子辐照后会在0.85 eV能级产生氮间隙缺陷[21-22],与图4c中Arrhenius曲线拟合出的(0.863±0.020) eV能级非常相似。因此推测AlGaN/GaN HEMTs在质子辐照后缺陷类型变为氮间隙缺陷。反向栅极漏电流的降低是由于质子辐照后处于缺陷状态的原子发生位移所致,质子将缺陷原子从导带附近移动到更深的位置,缺陷能级的加深降低了反向栅极漏电流,并且缺陷俘获载流子导致部分缺陷复合,缺陷浓度降低,载流子浓度降低也会使反向栅极漏电流降低。
在14 MeV中子实验后,进一步分析了位移损伤效应对AlGaN/GaN HEMTs器件的影响。图5为中子辐照前后的DLTS测试结果,辐照后峰值电容增加(缺陷浓度增加),峰值左移,这意味着缺陷能级变得更浅。与质子辐照后的测试结果相同,中子辐照后的能级为0.855(0.850±0.020) eV,缺陷类型为氮间隙缺陷,但缺陷浓度升高使反向栅极漏电流升高。

图5 中子辐照前后DLTS测试结果以及阿伦尼乌斯图Fig.5 DLTS spectra test results and Arrhenius plots determined before and after neutron irradiation
本文中质子辐照前后缺陷类型发生改变,并且质子与氮原子发生碰撞,导致原子移位(DLTS测试表现为峰值右移,缺陷能级加深),即质子辐照产生的位移损伤效应才是导致AlGaN/GaN HEMTs器件性能发生变化的根本原因。由于中子本身不带电,受到中子辐射后的器件性能发生变化的原因主要为位移损伤效应(中子碰撞产生的次级粒子导致的电离效应对器件造成的影响较质子入射导致的电离效应还要低得多)。而且中子辐照后的器件电学性能退化趋势(如饱和漏极电流降低、阈值电压正向漂移、峰值跨导下降)与质子辐照后一致,都认为是辐射粒子入射器件引起的氮间隙缺陷发生位移导致的位移损伤效应。由于实验条件的限制,本实验中的中子与质子的等效注量略有差异,但电学性能退化趋势相同。
4 结论
在AlGaN/GaN HEMT器件上进行了3 MeV质子和14 MeV中子辐照实验。当质子注量达到1015量级时,器件的电学特性发生退化,并且随着质子注量的增加,器件退化更为严重,缺陷俘获载流子导致部分缺陷复合,缺陷浓度降低,载流子浓度降低使反向栅极漏电流降低。而中子注量达到1013量级时,器件的电学特性同样发生退化,但缺陷浓度增加使反向栅极漏电流有所增加。DLTS验证表明,质子辐照退化机理与中子辐照一致,辐照后能级为(0.850±0.020) eV,推测缺陷类型为氮间隙缺陷,质子辐照和中子辐照后氮间隙缺陷主导的位移损伤效应是AlGaN/GaN HEMT器件性能变化的主要原因。

